SICASż╬ŗī1╗═╚Š┤³źŪĪ╝ź┐╩¼└Žż½żķĖ½ż©żŲż»żļĪó╚ŠŲ│öüŠÅČ╚ż╬ĮjżŁż╩╬«żņĪ╩2Ī╦
2011ŃQŗī1╗═╚Š┤³ż╦ż¬ż▒żļźĘźĻź│ź¾ICż╬Ö┌ŠÅē”╬üĪ”╝┬┼ĻŲ■ĮŚ┐¶ż╬źŪĪ╝ź┐ż╦ż¬żżżŲĪóMOS ICż╬”╠m╩╠ż╬źŪĪ╝ź┐ż¼ĀCŪ“żż’łĖ■ż“┐āżĘżŲżżżļż│ż╚ż╦Ążż¼¤²żżż┐ĪŻżĮżņżŽĪóMOS ICż╬Ö┌ŠÅē”╬üżŌ┼ĻŲ■┐¶żŌ0.12”╠m░╩æųż└ż╚ż█ż▄▓ŻżążżżŪ┐õöĪżĘżŲżżżļż╬ż╦×┤żĘżŲĪó0.06”╠mż½żķ0.12”╠m╠ż╦■ż▐żŪż╬ź”ź¦Ī╝źŽżŽžō┐ĻĪó0.06”╠m╠ż╦■ż╬ź”ź¦Ī╝źŽżŽ╗\▓├’łĖ■ż“┐āżĘżŲżżżļż│ż╚ż└ĪŻ


┐▐1ĪĪ”╠m╩╠MOS ICż╬Ö┌ŠÅē”╬üż╚╔nŲ»╬©ĪĪĮąųZĪ¦SICAS
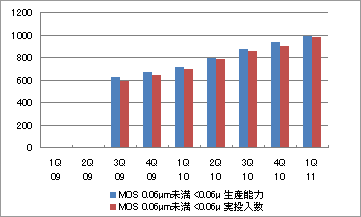
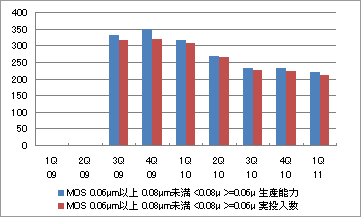
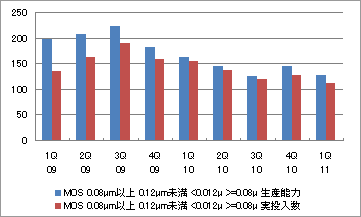
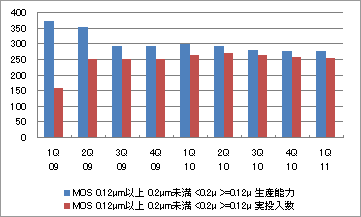
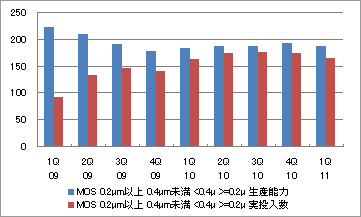
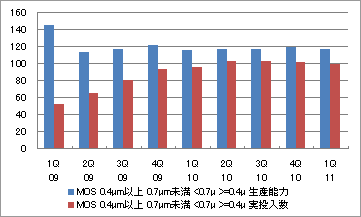
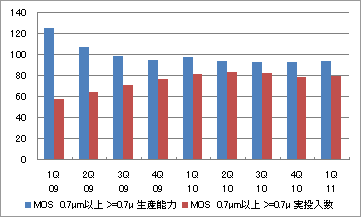
┐▐2ĪĪMOS ICż╬”╠m╩╠ż╬Ö┌ŠÅē”╬üż╚╝┬┼ĻŲ■ĮŚ┐¶(æųż½żķĪó║ŪżŌ╚∙║┘ż╩60nm╠ż╦■Īó60Ī┴80nmĪó80Ī┴120nmĪó0.12Ī┴0.2”╠mĪó0.2Ī┴0.4”╠mĪó0.4Ī┴0.7”╠mĪó0.7”╠m░╩æųż╬┐õöĪ)ĪĪĮąųZĪ¦SICAS
┐▐1żŽMOS ICµ£öüż╬Ų░Ė■ż“”╠m╩╠ż╦Ö┌ŠÅē”╬üż╚╝┬┼ĻŲ■ĮŚ┐¶żŪż▀ż┐żŌż╬ż└ż¼Īóµ£öü┼¬ż╦żŽ0.06”╠m(60nm)╠ż╦■ż╬ICżŽÖ┌ŠÅē”╬üżŌ╝┬┼ĻŲ■ĮŚ┐¶żŌäPżėżŲżżżļ══╗ęż¼ż’ż½żļĪŻż▐ż┐Īó60nm╠ż╦■żŪżŽż╩żżź”ź¦Ī╝źŽźūźĒź╗ź╣ż╬ICżŽČ”┘TżĘ¶öż▒żŲżżżļżĶż”ż╦Ė½ż©żļĪŻ
żĘż½żĘĪó”╠m╩╠źŪĪ╝ź┐ż“żĮżņżŠżņĖ½żļż╚(┐▐2)Īó║ŪĮķż╦Įęż┘ż┐’łĖ■ż¼żóżļż│ż╚ż¼Ų╔ż▀ż╚żņżļĪŻźĻĪ╝ź▐ź¾źĘźńź├ź»ĖÕż╬2009ŃQŗī3╗═╚Š┤³░╩æTżŪżŽ60nm╠ż╦■ż╬źūźĒź╗ź╣ź”ź¦Ī╝źŽż└ż▒ż¼ŠÆ╝┬ż╦äPżėżŲżżżļż¼Īó60nmĪ┴80nmźūźĒź╗ź╣Īó80nmĪ┴120nmźūźĒź╗ź╣ż╬ź”ź¦Ī╝źŽżŽÖ┌ŠÅē”╬üĪó╝┬┼ĻŲ■ĮŚ┐¶Č”ż╦╝Īŗīż╦žōż├żŲżżżļĪŻż╚ż│żĒż¼Īó0.12”╠mĪ┴0.2”╠mĪó0.2Ī┴0.4”╠mĪó0.4Ī┴0.7”╠mĪó0.7”╠m░╩æųż╬źūźĒź╗ź╣ż╬ź”ź¦Ī╝źŽżŽźĻĪ╝ź▐ź¾źĘźńź├ź»ż½żķöv╔³żĘż┐ĖÕżŽÖ┌ŠÅē”╬üĪó╝┬┼ĻŲ■┐¶ż╚żŌż╦░▌ĘeżĘżŲżżżļż╬żŪżóżļĪŻ
ź½ź«żŽArFźņĪ╝źČĪ╝ż╬āS─╣
ż╩ż╝ż½ĪŻżĮż╬ČŁų`ż“║ĖīÜż╣żļż╬ż¼źĻźĮź░źķźšźŻČ\ĮčżŪżóżļĪŻArFźņĪ╝źČĪ╝ż╬āS─╣żŽ193nmĪóż╣ż╩ż’ż┴0.193”╠mĪŻāS─╣żĶżĻżŌ║┘żżźņźĖź╣ź╚źčź┐Ī╝ź¾ż“▓├╣®ż╣żļŠņ╣ńż╦żŽĪóźčź┐Ī╝ź¾ż╬╔²öĄĖ■ż╬Ė„żŽź▐ź╣ź»ż╬│½Ė²ŗż╦Ų■żĻż╦ż»ż»Īóźčź┐Ī╝ź¾ż╬─╣żĄöĄĖ■żŽŲ■żĻżõż╣żżĪŻż│ż╬ż┐żßĪóźčź┐Ī╝ź¾ż¼Š’ż╦▐k─ĻöĄĖ■ż╦Ė■żżżŲżżżņżą▓├╣®żĘżõż╣żżż│ż╚ż╦ż╩żļĪŻ130nm╩šżĻż½żķāS─╣ż╬▒Ųūxż¼Įą╗ŽżßĪó90nmż╦ż╩żļż╚ź▐ź╣ź»źčź┐Ī╝ź¾ż“T┘ćżĘżŲ╦ŠżÓżĶż”ż╩źņźĖź╣ź╚źčź┐Ī╝ź¾ż¼ķWż▒żļżĶż”ż╦Īóżżż’żµżļOPCĪ╩optical proximity correctionĪ╦▌ö┘ćĮĶ═²ż“╣įż”ĪŻ
żĄżķż╦65nmĪó40nmż╚╚∙║┘▓ĮżĄżņövŽ®ż¼╩Ż╗©ż╦ż╩żļż╚ĪóźūźĒź╗ź╣źąźķż─żŁż╚Īóča┼┘żõ┼┼░Ąż╩ż╔ż╬╩čŲ░ż¼┴Ļż▐ż├żŲ┘抒ż╦Ų░║ŅżĘż╩ż»ż╩żļČ▓żņżŌ╗\żĘżŲż»żļĪŻż│ż╬ż┐żßĪóź▐ź╣ź»źčź┐Ī╝ź¾ż╬T┘濎EDAż╬├╩│¼ż½żķ╣įżżĪóżżż’żµżļDFMĪ╩design for manufacturingĪ╦ż╚żĘżŲźņźĖź╣ź╚źčź┐Ī╝ź¾ż¼źųźĻź├źĖż“ÅŚż│żĘżõż╣żżĖ─ĮĻż╩ż╔╔į╬╔ż╦ż╩żĻżõż╣żżĖ─ĮĻż“ź█ź├ź╚ź╣ź▌ź├ź╚ż╚żĘżŲ═Įżß└▀─ĻżĘżŲż¬żŁĪóźčź┐Ī╝ź¾ż“T┘ćżĘżŲż¬ż»ØŁ═ūż¼żóżļĪŻż│ż╬ź▐ź╣ź»źčź┐Ī╝ź¾ż╬T┘ć║ŅČ╚żŽĄżż╬▒¾ż»ż╩żļż█ż╔ż╬╩Ż╗©żŪ╦─Įjż╦żóżĻĪó╚∙║┘▓Įż╚Č”ż╦ź│ź╣ź╚żõ║ŅČ╚╬╠ż¼ĮjżŁż»ż½ż½żĻż╣ż«żļżĶż”ż╦ż╩żļĪŻż│ż╬ż┐żßEDAź─Ī╝źļżŽ’Lż½ż╗ż╩żżĪŻ
40nmĪó32nmĪó28nmĪó20nmż╚żĄżķż╦╚∙║┘▓Įż¼┐╩żÓż╚ĪóDFMż╬║ŅČ╚żŽż╚żŲż─żŌż╩ż»Įj╩čż╦ż╩żļĪŻżĘż½żĘĪó28nmżõ20nmż╚żżż├ż┐║Ū└Ķ├╝ż╬╚∙║┘▓├╣®Č\Į迎┬Š╝ęż╦żŽ╝┬ĖĮżŪżŁż╩żżż┐żßĮjżŁż╩║╣╩╠▓ĮČ\Įčż╚ż╩żĻż”żļĪŻż│ż╬ż┐żß║Ū└Ķ├╝ż╬źūźĒź╗ź╣ż“│½╚»żĘżŲżżżļIDMż╬źżź¾źŲźļżõźĄźÓź╣ź¾Īó┼ņėøż╩ż╔ż╚źšźĪź”ź¾ź╔źĻż╬TSMCżõź░źĒĪ╝źąźļźšźĪź”ź¾ź╔źĻĪ╝ź║żŽ└╦żĘż▓żŌż╩ż»1000▓»▀ģ├▒░╠ż╬┼Ļ½@ż“╣įżżĪó┬Š╝ęż╚ż╬═ź░╠└Łż“╩▌ż╚ż”ż╚żĘżŲżżżļĪŻ
▐köĄĪó0.2”╠m░╩æųż╬ArFźņĪ╝źČĪ╝ż╬āS─╣żĶżĻżŌ─╣żżźčź┐Ī╝ź¾żŽĪóż│ż╬żĶż”ż╩ĀC┼▌ż╩ż│ż╚żŽ╣įż’ż╩ż»żŲżŌ┴T┐▐żĘż┐─╠żĻż╬ź▐ź╣ź»źčź┐Ī╝ź¾żŪ└▀╝Ŗ┐▐ż¼żŪżŁżļĪŻź▐ź╣ź»└▀╝Ŗż╬▓■║¤ż╦╝Īż░▓■║¤ż╦╣®┐¶ż“ŲDżķżņżļż│ż╚żŽż╩żżĪŻżĮż╬┬Õż’żĻĪóż│ż”żżż├ż┐┤╦żżźčź┐Ī╝ź¾żŪ▒M╔ķżŪżŁżļ╚ŠŲ│öüźßĪ╝ź½Ī╝żŽ¤²▓├▓┴├═ż╬╣ŌżżĄĪē”żõ┤ļ▓Ķ╬üĪóŲ╚śOż╬źóźļź┤źĻź║źÓż╚żżż├ż┐Č\Įčź▐Ī╝ź▒źŲźŻź¾ź░╬üż“ŪõżĻرż╦żĘżŲżżżļĪŻ
ż─ż▐żĻ║Ū└Ķ├╝ż╬╚∙║┘▓ĮżŪźĻĪ╝ź╔ż╣żļż½Īó╚∙║┘▓Įż╚żŽ╠Ą▒’ż╬┤╦żżźūźĒź╗ź╣ż“╗╚żżĄĪē”żõ┤ļ▓Ķ╬ü(ź▐Ī╝ź▒źŲźŻź¾ź░╬ü)żŪ▒M╔ķż╣żļż½Īóżżż║żņż½ż╬╗■┬Õż╦ż╩ż├żŲżŁż┐ż╚żżż”ż│ż╚ż└ĪŻ├µ²ŗ╚Š├╝ż╩źūźĒź╗ź╣ż│żĮĪó65nmĪó90nmż╩ż╔żŪżóżļĪŻż└ż½żķź”ź¦Ī╝źŽ┼ĻŲ■╬╠ż¼▓╝ż¼żĻż─ż─żóżļż╚żżż©żļĪŻ40nmżŽ┤ųżŌż╩ż»ż│ż╬├ń┤ųż╦ż╩żĻ▓╝ż¼żļĪŻ
ż▐ż┐╚∙║┘▓ĮźūźĒź╗ź╣żŽĪóż½ż─żŲż╬Īų└ż┬ÕĪūż╚żŽ░Ńż”ĪŻ90nmĪó65nmĪó45nmĪó32nmĪóż╩ż╔żžż╚┐╩żÓżŽż║ż└ż├ż┐ż¼Īó║Żżõ├µ²ŗ╚Š├╝ż╩źūźĒź╗ź╣ż“ź╣źŁź├źūżĘżŲĪóżżżŁż╩żĻ╚∙║┘▓Įżžż╚╚¶żųż│ż╚ż¼¾HżżĪŻ3Ī┴4ŃQØi║ŪĮķż╦źżź¾źŲźļż¼AtomźūźĒź╗ź├źĄż“ĮążĘżŲżŁż┐╗■ĪóAtomżŽ45nmźūźĒź╗ź╣żŪ└▀╝ŖżĄżņż┐ż¼ĪóżĮż╬ź│ź¾źčź╦ź¬ź¾ź┴ź├źūżŽ130nmźūźĒź╗ź╣żŪ║ŅżķżņżŲżżż┐ĪŻżŌż┴żĒż¾ż│ż╬ź│ź¾źčź╦ź¬ź¾ź┴ź├źūżŽ90nmĪó65nmż“ź╣źŁź├źūżĘż┐ĪŻFPGAźßĪ╝ź½Ī╝ż╬źķźŲźŻź╣ź╗ź▀ź│ź¾ź└ź»ź┐Ī╝żŽ65nmź┴ź├źūż╬╝Īż╦żŽ28nmź┴ź├źūżžż╚╚¶żų═Į─Ļż└Ī╩╗▓╣═½@╬┴1Ī╦ĪŻ
źšźĪźųźķźżź╚└’ŠSż¼Õeż”żżż╬żŽĪóż│ż╬├µ²ŗ╚Š├╝ż╩źūźĒź╗ź╣ż╦╔w╝╣żĘżŲżżżļż│ż╚ż└ĪŻ╚∙║┘▓Įż“┐╩żßżļż½ĪóČ\Įčź▐Ī╝ź▒źŲźŻź¾ź░╬üż“╣Ōżßżļż½Īóż╔ż┴żķż½żĘż½╚ŠŲ│öüźßĪ╝ź½Ī╝ż╬Ö┌żŁżļ╠OżŽżóżĻįuż╩żżż│ż╚ż“SICASż╬┼²╝ŖżŽČĄż©żŲżżżļĪŻ
╗▓╣═½@╬┴
1. 65nmż╬╝ĪżŽ28nmźŪźČźżź¾ż“┐õ┐╩ż╣żļźķźŲźŻź╣ĪóŲ³╦▄ż╬źšźĪź”ź¾ź╔źĻżŽ▌xŠņ┴ė╝║ (2011/05/25)


