NECĪóIMECż╬TSVż╦żĶżļ3╝ĪĖĄICĪó╝┬├ō▓Įż╦Ė■ż▒▐k╩ŌØi┐╩
Å──╠┼┼Č╦ż“╗╚ż├żŲĪó═Ų╬╠ż╬ĮjżŁż╩źŪź½ź├źūźĻź¾ź░ź│ź¾źŪź¾źĄż“Ę┴└«żĘż┐żĻĪóĄšż╦Å──╠┼┼Č╦ż╚Siź┴ź├źūżóżļżżżŽźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż╚ż╬┤¾Ö┌═Ų╬╠ż“▓╝ż▓żļż┐żßż╦Ė³żżŃ~ĄĪ└õ▒’╦ņż“└▀ż▒ż┐żĻż╣żļż╩ż╔Īó3╝ĪĖĄICČ\Įčż╬╝┬├ō▓Įż¼┐╩ż¾żŪżżżļĪŻ╔wöü┴Ū╗ę║Ó╬┴ź│ź¾źšźĪźņź¾ź╣Ī╩SSDMĪ╦2008żŪżŽĪóNECż╚ź┘źļź«Ī╝ż╬IMECż¼żĮżņżŠżņTSVż╬╝┬├ō▓Įż╦Ė■ż▒ż┐Ė”ē|ż“╚»╔ĮżĘż┐ĪŻ
NECźŪźąźżź╣źūźķź├ź╚źšź®Ī╝źÓĖ”ē|ĮĻżŽĪó3╝ĪĖĄICż╬Å──╠┼┼Č╦ż╚║ŲŪ█└■ż╬╠“│õż“Ęeż─ĪóźĘźĻź│ź¾źżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż╦źŪź½ź├źūźĻź¾ź░ź│ź¾źŪź¾źĄż“║ŅżĻ╣■ż¾żŪżĘż▐ż”ż╚żżż”Č\Įčż“│½╚»żĘż┐ĪŻźŪźĖź┐źļLSIż¼╚»Ö┌ż╣żļź╬źżź║ż“═▐ż©żļż┐żßż╦Īóż│ż╬źŪź½źūźĻź¾ź░ź│ź¾źŪź¾źĄż╬═Ų╬╠ż“”╠Fź¬Ī╝ź└Ī╝ż╚ĮjżŁż»żĘĪó╝■āS┐¶▒■┼·żŌÅ]ż»ż╣żļØŁ═ūż¼żóżļĪŻż│ż╬ż┐żßäė═Č┼┼öü║Ó╬┴ż“źŁźŃźčźĘź┐└õ▒’╦ņż╦├ōżżż┐ĪŻ

ż│ż╬źżź¾ź┐Ī╝ź▌Ī╝źČĪ╝żŽĪóLSIż╚ż█ż▄Ų▒żĖĮjżŁżĄżŪĪóLSIż╚ż╬└▄¶öż╦żŽÅ──╠┼┼Č╦TSVĪ╩through silicon viaĪ╦ż“├ōżżżŲżżżļĪŻżĮż╬źżź¾ź┐Ī╝ź▌Ī╝źČĪ╝żŽLSIźčź├ź▒Ī╝źĖ┤łż╚żĮż╬ż▐ż▐└▄¶öż╣żļĪŻ║ŻövĪó¾H┐¶ż╬ź┴ź├źūż“Siź”ź¦Ī╝źŽźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż╦╝┬äóżĘĪ󟔟¦Ī╝źŽźņź┘źļźčź├ź▒Ī╝źĖź¾ź░Ī╩WLPĪ╦Č\ĮčżŪ╝┬äóżĘż┐ź┴ź├źūż“└┌żĻĮąż╣Īóź┴ź├źūĪ”ź─Ī╝Ī”ź”ź¦Ī╝źŽ└▄¶öČ\Įčż“├ōżżż┐ĪŻ
ż▐ż║ĪóSiź”ź¦Ī╝źŽźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝µ£ĀCż╦MIMĪ╩ČŌō’-└õ▒’╦ņ-ČŌō’Ī╦ż╬źŁźŃźčźĘź┐ż“Ę┴└«ż╣żļĪŻźŁźŃźčźĘź┐ż╬═Č┼┼öüSrTiO3ż╬Ė³ż▀żŽ60nmĪŻżĮż╬ĖÕĪóźĘźĻź│ź¾┤łż╦TSVż╚ż╩żļŗ╩¼ż╬źĘźĻź│ź¾ż“50”╠mµć┼┘ż╬┐╝żĄż▐żŪź©ź├ź┴ź¾ź░żĘĪó└õ▒’╦ņż“▓żĘżŲ┼┼Č╦ż“ļmżß╣■żÓĪŻĮą═Ķż┐┼┼Č╦æųż╦¾H┐¶ż╬LSIź┴ź├źūż“╝┬äóżĘĪóźóź¾ź└Ī╝źšźŻźļżŪ╔w─ĻżĘż┐ĖÕĪóź┴ź├źūŗ╩¼ż“źŌĪ╝źļźŪźŻź¾ź░ż╣żļĪŻżĮż╬ĖÕĪóSiźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż“50”╠mż▐żŪŪ÷ż»║’żļż│ż╚żŪźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż╦ļmżß╣■ż¾ż└┼┼Č╦ż“Ž¬ĮążĄż╗żļĪŻżĮż╬æųż╦żĄżķż╦┼┼Č╦źčź├ź╔ż“└▀ż▒żļż╚WLPż¼┤░└«ż╣żļĪŻ
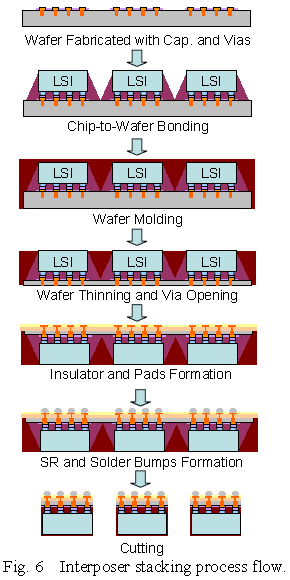
Siźżź¾ź┐Ī╝ź▌Ī╝źČĪ╝ż“└č┴žżĘż┐3╝ĪĖĄICź┴ź├źūż“-40Ī┴+125ĪŅż╬ča┼┘źĄźżź»źļ╗Ņ┘xż“1000öv╣įż├ż┐ż¼Īó8Ė─ż╬╗Ņ╬┴żŽż╣ż┘żŲźčź╣żĘż┐ĪŻźŁźŃźčźĘź┐ź¾ź╣żŽź┴ź├źū1Ė─ż╦ż─żŁ1”╠Fµć┼┘żóżļĪŻ
IMECżŽĪóÅ──╠┼┼Č╦ż╚źĘźĻź│ź¾ż╬╩╔ż╚ż╬┤ųż“5”╠mż╚Ė³żżź▌źĻź▐Ī╝╦ņżŪ└õ▒’ż╣żļż╚żżż”Č\Įčż“│½╚»żĘż┐ĪŻż│żņż▐żŪżŽ50Ī┴100nmż╬CVD¤©▓Į╦ņżõ├Ō▓Į╦ņżŪä┘ż├żŲżżż┐ż¼ĪóÅ──╠┼┼Č╦ż╬┤¾Ö┌═Ų╬╠ż¼▓╝ż¼żķż╩ż½ż├ż┐ĪŻ║ŻövżŽżĮż╬50Ī┴100Ū▄żŌż╬Ė³żĄż╬ż┐żß┤¾Ö┌═Ų╬╠żŽ“£═Ķż╬1/50Ī┴1/100ż╦ż╩żļĪŻ
ż│ż│żŪżŽĪóźčźżźņź├ź»ź╣ź¼źķź╣æųż╦źßź┐źļż“źčź┐Ī╝ź╦ź¾ź░żĘżŲż¬żŁĪóĖ³żĄ50”╠mż╬Siź”ź¦Ī╝źŽż“żĮż╬æųż╦║▄ż╗żļĪŻźņźĖź╣ź╚┼╔╔█Ī”źčź┐Ī╝ź╦ź¾ź░ĪóRIEź©ź├ź┴ź¾ź░ż╦żĶżĻ▀ģ├ņż“ż»żĻģsż»żĶż”ż╦źĻź¾ź░ėXż╦źĘźĻź│ź¾ż“║’żļĪŻ└õ▒’╦ņż╚żĘżŲŲ»ż»ź▌źĻź▐Ī╝ż“┼╔╔█ż╦żĶżĻ║’ż├ż┐źĻź¾ź░ėXż╬ĘĻż“ļmżßĪóźņźĖź╣ź╚ż“┼╔╔█źčź┐Ī╝ź╦ź¾ź░żĘż┐ĖÕ╗─ż├ż┐Siż╬▀ģ├ņż“ź©ź├ź┴ź¾ź░żŪ║’żļĪŻżĮż╬ĖÕźĘĪ╝ź╔źßź┐źļĪóCuźßź├źŁļmżß╣■ż▀ż╦żĶżĻ┼┼Č╦ż“Ę┴└«ż╣żļĪŻ
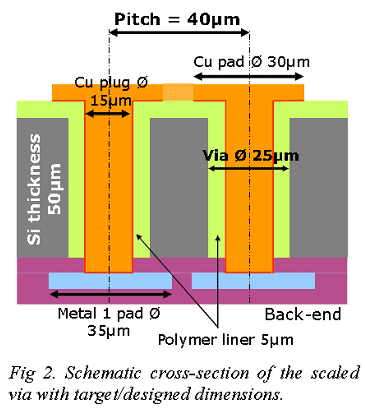
╚»╔ĮżĘż┐IMEC Process Technology Divisionż╬Interconnect, Packaging & Systems Integration├┤┼÷Ė”ē|µ^ĪóDeniz Sabuncuoglu TeczanĢ■żŽĪó║Żövż╬»éżßŠ}ż╚ż╩żļźĻź¾ź░ėXźčź┐Ī╝ź¾ż╬ź©ź├ź┴ź¾ź░żŽ“£═Ķż╬ź▄ź├źĘźÕźūźĒź╗ź╣ż“╗╚żżĪó3”╠m/╩¼ż╬ź©ź├ź┴źņĪ╝ź╚żŪ╣įż├ż┐ż┐żß▓╝ż▐żŪÅ──╠ż╣żļż╬ż╦15~16╩¼żŪż╣ż¾ż└ż╚Ė└ż”ĪŻ


