GaNż╬Š’╝▒ż“ä┘ż╣1200Vż╬Č\ĮčżŪEV▌xŠņż“┴└ż”źčź’Ī╝╚ŠŲ│öüź┘ź¾ź┴źŃĪ╝
╣Ō┬č░Ąż╬źčź’Ī╝╚ŠŲ│öüż╦żŽĪóرä®ØŖ└Łż╚żĘżŲSiżĶżĻżŌ└õ▒’┬č░Ąż╬╣ŌżżSiCżõGaNż╬öĄż¼Ń~ŠWż└ĪŻżĘż½żĘż╩ż¼żķSiCżŪżŽ1200Vż╬┬č░Ąż“įużķżņżļż¼Īó╣Ō▓┴żŪż╩ż½ż╩ż½╔ߥ┌żĘż╩żżĪŻGaNż╬▓ŻĘ┐HEMTź╚źķź¾źĖź╣ź┐żŽ650Vµć┼┘żĘż½┬č░Ąż¼įużķżņż╩żżĪŻż│ż¾ż╩Š’╝▒ż¼SiĪóSiCĪóGaNż╬źčź’Ī╝╚ŠŲ│öüżŪż│żņż▐żŪż▐ż½żĻ─╠ż├żŲżżż┐ĪŻ
ż│żņż“ä┘ż╣żĶż”ż╩GaNźŪźąźżź╣ż“╠Ąć@ż╬ź┘ź¾ź┴źŃĪ╝ż¼│½╚»żĘż┐ĪŻźčź’Ī╝╚ŠŲ│öüż“╗ųż╣źčź”źŪź├ź»Ī╩PowdecĪ╦╝ęż└ĪŻĖĄźĮź╦Ī╝├µ▒¹Ė”ē|ĮĻĮą┐╚ż╬ąQ╣ń╣░█EĢ■ż¼2001ŃQ5ĘŅż╦┴ŽČ╚żĘż┐▓±╝ężŪżóżļż¼ĪóŲ╚śOż╦│½╚»żĘż┐╣Ō┬č░ĄGaNż“ź│źóż╚żĘżŲźčź’Ī╝╚ŠŲ│öüż╬┐Ę╩¼╠Ņż“└┌żĻ│½ż│ż”ż╚żĘżŲżżżļĪŻ∙Z£I10═ŠŃQĪó2013ŃQż╦ØŖß׿“┐ĮæąĪó░╩æT13°Pż╬┤╦▄ØŖß׿“ŲDįużĘż┐ĪŻķL│░ØŖß׿Ō9°PĮĻŃ~ż╣żļĪŻ
ż│żņż▐żŪ╝┬║▌ż╦╗Ņ║Ņż“╣įżżĪó╣Ō┬č░ĄŲ░║Ņż“╝┬Š┌ż╣żļż╬ż╦10ŃQ░╩æųż½ż½ż├ż┐ĪŻż│ż╬┤ųĪó┬č░Ą3300VĪó6600VĪó1╦³Żųż╬▓ŻĘ┐GaN HEMTźčź’Ī╝ź╚źķź¾źĖź╣ź┐ż“│½╚»╗Ņ║ŅżĘżŲżŁż┐ĪŻČ\Įč│½╚»╬üżŽżóż├żŲżŌż│ż╬┤ųĪóźėźĖź═ź╣żŽż╩ż½ż╩ż½┐╩ż▐ż╩ż½ż├ż┐ĪŻżĘż½żĘĪóżĶż”żõż»║ŪŖZż╦ż╩ż├żŲGaNźėźĖź═ź╣ż¼╬®ż┴æųż¼żĻ╗Žżßż┐ĪŻ2020ŃQ4ĘŅż╦┬Õ╔ĮŲD─∙╠“╝ę─╣ż╦┼×ŪżżĘż┐└«░µĘ╝TĢ■Ī╩┐▐1Ī╦żŽĪóEVĪ╩┼┼ĄżśOŲ░┘ZĪ╦▌xŠņż╬┤³ż¼▌^żĘ╗Žżßż┐ż╚Ė½żļĪŻ

┐▐1ĪĪźčź”źŪź├ź»╝ę┬Õ╔ĮŲD─∙╠“ż╬└«░µĘ╝TĢ■Ī╩║ĖĪ╦ż╚Ų▒╝ęŲD─∙╠“Ī”┼┼╗ęźŪźąźżź╣Č\Įč┴Ē│ńż╬╚¼“vT▐kĢ■Ī╩īÜĪ╦
EVżŪżŽ╠¾4Vż╬źĻź┴ź”źÓźżź¬ź¾┼┼├ėź╗źļż“─Šš`ż╦100Ė─µć┼┘└▄¶öżĘż┐400Vż╬źąź├źŲźĻźčź├ź»ż¼źŌĪ╝ź┐Ī╝ż“Ų░ż½ż╣ź©ź═źļź«Ī╝ż╚ż╩żļĪŻ400Vż╬ź©ź═źļź«Ī╝ż“ź¬ź¾ź¬źšżĄż╗żļż│ż╚żŪźŌĪ╝ź┐Ī╝ż“Ų░ż½ż╣Ė“╬«ż“Ö┌ż▀Įąż╣ż’ż▒ż└ż¼Īóż│ż│ż╦650VżóżļżżżŽ750V┬č░Ąż╬źčź’Ī╝ź╚źķź¾źĖź╣ź┐ż¼╗╚ż’żņżŲżŁż┐ĪŻżĘż½żĘĪó║ŪŖZż╬ŠåÅ]Į╝┼┼żŪżŽż│ż╬µć┼┘ż╬┬č░ĄżŪżŽ╔įØ▓╩¼ĪŻ800Vż“ź»źļź▐ż╦▓├ż©żŲĮj┼┼╬üżŪĮ╝┼┼ż╣żļż½żķż└ĪŻż│ż╬ż┐żßźčź’Ī╝ź╚źķź¾źĖź╣ź┐ż╦żŽ1200Vµć┼┘ż╬┬č░Ąż¼ĄßżßżķżņżļĪŻāį┼Ž┼¬ż╦ź╬źżź║ż╩ż╔żŪ1000Vµć┼┘ż╬╣Ō┼┼░Ąż¼▓├ż’żļż│ż╚żŌŪ█╬ĖżĘżŲżżżļĪŻĖĮ║▀ĪóSiCż¼Teslaż╬EVĪųźŌźŪźļ3Īūż╦║╬├ōżĄżņżŲżżżļĪŻżĘż½żĘSiCżŽ╣Ō▓┴ż╩ż┐żß╔ߥ┌ż¼┐╩ż¾żŪżżż╩żżĪŻ
źĄźšźĪźżźó┤łæųż╦Ę┴└«żĄżņżļGaNżŽĪó×E┐¦LEDżõŠ╚£½├ōŪ“┐¦LEDżŪż╣żŪż╦20ŃQ░╩æųż╬╝┬└ėż“Ęeż├żŲż¬żĻĪóSiCż█ż╔╣Ō▓┴żŪżŽż╩żżĪŻżĘż½żĘĪóż│żņż▐żŪżŽ┐¶10Aż╬┼┼╬«ż“╬«ż╣źčź’Ī╝╚ŠŲ│öüżŪżŽ650Vż▐żŪżĘż½┬č░Ąż¼żŌż┐ż╩żżĪóż╚Ė└ż’żņżŲżŁż┐ĪŻżĮż╬╣═ż©ż“ä┘ż╣Č\Įčż¼źčź”źŪź├ź»ż╬źčź’Ī╝╚ŠŲ│öüČ\ĮčżŪżóżļĪŻ
į~├▒ż╦żĮżņż“Šę▓żĘżĶż”ĪŻGaNźčź’Ī╝╚ŠŲ│öüżŽĪóż│żņż▐żŪżŽ╔┘╗╬─╠ż¼╚»£½żĘż┐HEMTĪ╩╣ŌöĪŲ░┼┘ź╚źķź¾źĖź╣ź┐Ī╦╣Įļ]ż“┤╦▄ż╚żĘĪó┼┼╬«żŽ╚ŠŲ│öü╔ĮĀCż╦╬«żņżļ▓ŻĘ┐ź┐źżźūżŪżóż├ż┐ĪŻźčź”źŪź├ź»żŽĪóż│ż╬╣Įļ]ż╦Š}ż“▓├ż©żŲĪó┼┼░Ąż¼▓├ż’ż├ż┐ż╚żŁż╦┼┼─cäė┼┘ż“▐k─Ļż╦ż╣żļ╣Įļ]Ī╩źóź¾ź╔Ī╝źūż╬GaN┴žĪ╦ż“Ų│Ų■żĘż┐ż╬żŪżóżļĪŻ
HEMT╣Įļ]ż╬ź╚źķź¾źĖź╣ź┐żŽĪóźąź¾ź╔ź«źŃź├źūż╬╣ŁżżAlGaN┴žż╚ź╔Ī╝źūżĘż╩żżGaN┴žż╚ż╬─cĀCż╦2╝ĪĖĄ┼┼╗ęź¼ź╣ż“╚»Ö┌żĄż╗Īóź╔źņźżź¾ż½żķźĮĪ╝ź╣żž╩┐ĀCæųż“┼┼╬«ż¼╬«żņżļźŪźąźżź╣żŪżóżļĪ╩┐▐2Ī╦ĪŻźĄźšźĪźżźó┤łæųż╬źóź¾ź╔Ī╝źūGaNż╚żĄżķż╦źąź¾ź╔ź«źŃź├źūż╬╣ŁżżAlGaNż╚ż╬┤ųż╬─cĀCż╬źóź¾ź╔Ī╝źūGaNŖõż╦▐pż├żŲ2╝ĪĖĄ┼┼╗ęż¼źĮĪ╝ź╣ż½żķź╔źņźżź¾żž┴÷╣įżĘżŲżżż»ĪŻ╩┐ĀC┼¬ż╦┼┼╗ęż¼┴÷żļż│ż╚żŪĪó╔įĮŃرÜg═żõ│╩╗ęÜg═ż╬▒Ųūxż“ż▐ż╚żŌż╦£pż▒ż╦ż»żżż│ż╚ż½żķ┼┼╗ęöĪŲ░┼┘ż¼╣Ōż»─Ń°BŃ^żŪ┼┼╬«ż“╬«ż╣ż│ż╚ż¼żŪżŁżļĪŻpĘ┐GaNż╬ź▓Ī╝ź╚ż╦ź▐źżź╩ź╣ż╬┼┼░Ąż“ż½ż▒żļż╚źóź¾ź╔Ī╝źūGaNż╦ȧĒś┴žż¼╣Łż¼żĻ2╝ĪĖĄ┼┼╗ęź¼ź╣ż“╝ūéāż╣żļż│ż╚żŪ┼┼╬«ż“ź½ź├ź╚ż╣żļĪŻżżż’żµżļź╬Ī╝ź▐źĻź¬ź¾Ę┐ż╬FETż╬▐k¹|żŪżóżļĪŻ
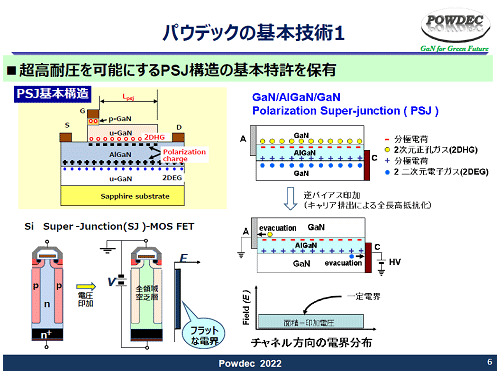
┐▐2ĪĪ“£═Ķż╬HEMT╣Įļ]ż╦▓├ż©żŲĪóź▓Ī╝ź╚p-GaNż╚AlGaNż╚ż╬┤ųż╦źóź¾ź╔Ī╝źūż╬GaNż“▓├ż©ż┐ż│ż╚żŪĪóAlGaN┴žŲŌŗż╦╩¼Č╦ż“Ö┌żĖżĄż╗ĪóĄšźąźżźóź╣ż“ż½ż▒ż┐╗■ż╦µ£żŲż╬2╝ĪĖĄ┼┼╗ęź¼ź╣ż“┴Ū┴ßż»ŪėĮ³żŪżŁżļżĶż”ż╦żĘż┐ĪŻż│ż╬ż│ż╚żŪź╔źņźżź¾Ī╝źĮĪ╝ź╣┤ųż╬┼┼─cż¼Čč▐kż╦ż╩żĻ┬č░Ąż“æųż▓żķżņżļżĶż”ż╦ż╩ż├ż┐ĪĪĮąųZĪ¦źčź”źŪź├ź»
╔ķż╬ź▓Ī╝ź╚┼┼░Ąż╦żĶżļȧĒś┴žżŽź┴źŃź¾ź═źļż▐żŪäPżėżŲżŁżŲ2╝ĪĖĄ┼┼╗ęź¼ź╣ż“ź½ź├ź╚ż╣żļż│ż╚żŪ┼┼╬«ż¼╬«żņż╩żżż└ż▒żŪżŽż╩ż»Īóź╔źņźżź¾ż╚źĮĪ╝ź╣ż╦╗─ż├ż┐2╝ĪĖĄ┼┼╗ęź¼ź╣żŌ┴Ū┴ßż»ŪėĮ³ż╣żļż│ż╚żŪź┴źŃź¾ź═źļµ£öüż╦┼ŽżĻ┼┼─cäė┼┘ż¼▐k─Ļż╦ż╩żĻĪóČ╔ĮĻ┼¬ż╦┼┼─cż¼╣Ōżżż╚ż│żĒż¼ż╩ż»ż╩żļĪŻż│żņż¼╣Ō┬č░Ąż╦żŪżŁż┐ź½ź«żŪżóżļĪŻ▐k╚╠ż╦┼┼╗ężõ┘ć╣”ż¼╗─ż├żŲżżżņżąČ╔ĮĻ┼¬ż╦┼┼─cż¼╩čż’żĻżĮż│ż╦┼┼─cż¼ĮĖ├µż╣żņżą┬č░ĄżŽ─Ńż»ż╩żļĪŻźčź”źŪź├ź»ż╬HEMTżŪżŽĪóAlGaN╦ņż╬æųż╦żĄżķż╦╩╠ż╬źóź¾ź╔Ī╝źūGaN┴žż“└▀ż▒ĪóAlGaN╦ņż╬æų▓╝ż╦┼┼╗ęż╚┘ć╣”ż╬ź▀źķĪ╝╣Įļ]ż“└▀ż▒żļż│ż╚żŪĪ󟣟џĻźóż“┴Ū┴ßż»ģsż▒żļżĶż”ż╦żĘĪó┼┼─cĮĖ├µż“ķcż▒┼┼─cäė┼┘ż“▐k─Ļż╦╩▌ż─żĶż”ż╦żĘż┐ĪŻ
×æļ]æųżŪżŌĪóźķź¾źūāįÕXż╦żĶżļMOCVDĪ╩Ń~ĄĪČŌō’▓Į│ž┼¬Ąż┴Ļ└«─╣Ī╦äóÅøż╦ż¬żżżŲź”ź¦Ī╝źŽż“Ž¦┐┤┤╔ŲŌż╬ÜW░µż╦Ū█ÅøżĘ╚┐▒■ź¼ź╣ż¼ÜW░µż╬ź”ź¦Ī╝źŽż╦ī\└čż╣żļżĶż”ż╦żĘż┐ĪŻ“£═Ķż╬äóÅøżŪżŽŽ¦┐┤┤╔ż╬öfż╦ź”ź¦Ī╝źŽż“Ū█ÅøżĘżĮż╬æųż╦ī\└čżĘżŲżżż┐ż¼ĪóŽ¦┐┤┤╔ż╬ÜW░µż╦żŌī\└čż╣żļÖ┌└«Ø±ż¼ź”ź¦Ī╝źŽæųż╦ż╚żŁż╔żŁŁéż¼żņ═Ņż┴żŲżĘż▐ż”ż│ż╚ż¼żóż├ż┐ż┐żßĪóČč▐kż╩Ū÷╦ņż“Ę┴└«ż╣żļż│ż╚ż¼žMżĘż½ż├ż┐ĪŻ╩Ōé╬ż▐żĻżŌæųż¼żķż╩ż½ż├ż┐ż╚żżż”ĪŻ
ż│żņżķŲ¾ż─ż╬┤╦▄Č\Įčż╬ØŖß׿“ŲDįużĘżŲżżżļĪŻżĘż½żŌ╗Ņ║ŅżŪ│╬Ū¦żĘżŲż¬żĻĪóż│żņżķż¼źčź”źŪź├ź»ż╬┤╦▄Č\Įčż╚ż╩żļĪŻ
ż╩ż╝▓ŻĘ┐ż╬HEMT╣Įļ]ż╦ż│ż└ż’żļż╬ż½Īóż▐ż┐źĘźĻź│ź¾┤łż“╗╚ż’ż║ż╦źĄźšźĪźżźó┤łż“╗╚ż”ż╬ż½ĪŻ╝┬żŽźĘźĻź│ź¾┤łæųż╬GaNżŽĪóż│żņż▐żŪ─Ńź│ź╣ź╚ż╦żŪżŁżļż│ż╚ż½żķ┤³┬įżĄżņżŲżżż┐ż¼Īó±TŠĮ’L┤┘ż¼¾Hż╣ż«żŲĪóHEMTż╩ż╔ż╬ź╚źķź¾źĖź╣ź┐żŪżŽźĻĪ╝ź»┼┼╬«ż¼¾Hż╣ż«żŲ╝┬├ō┼¬żŪżŽż╩żżż╚żżż”Ī╩┐▐3Ī╦ĪŻż▐ż┐ĪóSi┤łżŽ─cĀCØŹ░╠ż╬¾HżżĪ╩111Ī╦ĀCżŪGaNż“└«─╣żĄż╗żŲżżżļż┐żßĪóį~├▒ż╦żŽSi LSIż“ĮĖ└čżŪżŁż╩żżĪŻ
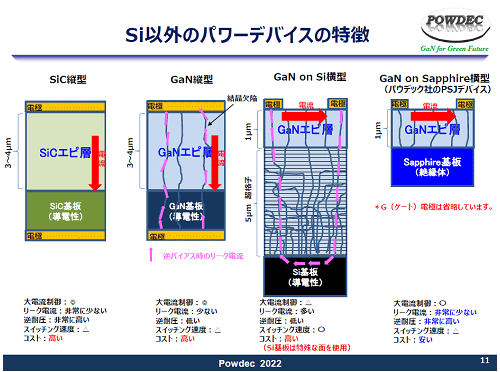
┐▐3ĪĪāeĘ┐SiCż╚GaNĪ󿥿ķż╦GaN-on-Siliconż╚żŌ╚µ│ėĪĪĮąųZĪ¦źčź”źŪź├ź»
▐köĄżŪź”ź¦Ī╝źŽż╬╬óĀCż½żķ╔ĮĀCż╦╬«żņżļāeĘ┐ż╬GaN±TŠĮż╬Ė”ē|żŌżóżļĪŻżĘż½żĘĪóSiCż╚Ų▒══Īó╣Ō▓┴ż└ĪŻż▐ż┐āeöĄĖ■ż╦┴÷ż├żŲżżżļ±TŠĮ’L┤┘ż╦▐pż├żŲ┼┼╬«ż¼╬«żņżļż╚’L┤┘ż¼╗\ż©żŲż»żļż╚żżż”ĪŻż│ż╬ż┐żß┐«═Ļ└Łż¼ĄKż½ż├ż┐ĪŻż│ż╬┼└Ī󟥟šźĪźżźó┤łæųż╬GaNżŪ╣Į└«ż╣żļ▓ŻĘ┐HEMTżŽźĻĪ╝ź»┼┼╬«ż¼Š»ż╩ż»ĪóĮj┼┼╬«ż¼ŲDżņżļż╚żżż”ĪŻżĘż½żŌźĄźšźĪźżźóżŽ└õ▒’öüżŪżóżļż½żķ100µmµć┼┘ż╦Ū÷ż»║’żļż│ż╚żŪźčź├ź▒Ī╝źĖż╬ČŌō’┤łż╦żĮż╬ż▐ż▐ż─ż╩ż░ż│ż╚ż¼żŪżŁżļĪŻżĄżķż╦żĮż╬┤łż“╩³ÕXźšźŻź¾ż╦żŌ─Š±TżŪżŁżļĪŻ
źŪźąźżź╣ż╬┼┼╬«┼┼░Ąż╩ż╔ż╬¼śØŖ└Łż└ż▒żŪżŽż╩ż»Īóź╣źżź├ź┴ź¾ź░ØŖ└Łż╩ż╔ż╬Ų░ØŖ└ŁżŌ▒R─ĻżĘżŲżżżļĪŻźŪźąźżź╣żŌź╚źķź¾źĖź╣ź┐ż└ż▒żŪżŽż╩ż»źĘźńź├ź╚źŁĪ╝źąźĻźóź└źżź¬Ī╝ź╔żŌ×æ║ŅżĘżŲżżżļĪŻ╬Ńż©żąź╚źķź¾źĖź╣ź┐ż╦400Vż╬─Š╬«┼┼░Ąż“ż½ż▒Īó20Aż“źżź¾ź└ź»ź┐╔ķ▓┘ż╬źŲź╣ź╚övŽ®ż╦ż¬żżżŲ╝■āS┐¶1MHzżŪź╣źżź├ź┴ź¾ź░ż╣żļāSĘ┴żŌ▒R─ĻżĘżŲżżżļĪŻź┐Ī╝ź¾ź¬ź¾╗■┤ų15.6nsĪóź┐Ī╝ź¾ź¬źš╗■┤ų15.7nsż╚żŁżņżżż╩āSĘ┴ż“┐āżĘżŲżżżļĪŻż▐ż┐źĘźńź├ź╚źŁĪ╝ź└źżź¬Ī╝ź╔żŽĪóź╬źżź║ż╬Š»ż╩żżĄšöv╔³āSĘ┴ż“┐āżĘżŲżżżļĪŻ
źčź”źŪź├ź»ż╬źėźĖź═ź╣źŌźŪźļżŽĪó3źżź¾ź┴ż╚4źżź¾ź┴ż╬źĄźšźĪźżźóź”ź¦Ī╝źŽæųż╦GaNź©źįź┐źŁźĘźŃźļ┴žż“Ę┴└«żĘż┐ź”ź¦Ī╝źŽż╬╚╬Ūõż╚ĪóGaNź╚źķź¾źĖź╣ź┐ż╬×æļ]╚╬ŪõĪ󿥿ķż╦ź▓Ī╝ź╚ź╔źķźżźąICżŌ┼ļ║▄żĘż┐źčź’Ī╝źŌźĖźÕĪ╝źļż╬×æļ]╚╬ŪõĪ󿬿Ķżėźķźżź╗ź¾ź╣/źĒźżźõźļźŲźŻ╚╬ŪõżŪżóżļĪ╩┐▐4Īó5Ī╦ĪŻŠ«żĄż╩źėźļż╬╗Ņ║Ņ╣®Šņż╦ź»źĻĪ╝ź¾źļĪ╝źÓż“└▀ÅøżĘĪó±TŠĮ└«─╣ż½żķźŪźąźżź╣×æ║Ņż▐żŪŠ}²Xż▒żļĪŻ╗Ņ║Ņ│½╚»├ōż╬×æļ]źķźżź¾żŪżóżļż┐żßĪóGaNź╚źķź¾źĖź╣ź┐ż╬×æ║Ņż╦żŽ─ŠĘ┬3źżź¾ź┴ż╚4źżź¾ź┴ż╬źĄźšźĪźżźóź”ź¦Ī╝źŽ┤łż“╗╚ż├żŲżżżļĪŻ╗Ņ║ŅżĘż┐GaNź╚źķź¾źĖź╣ź┐ż╬ź┴ź├źūĀC└迎6mmĪ▀4mmĪŻ1ĮŚż╬ź”ź¦Ī╝źŽż½żķ┐¶Ø▓Ė─ż╚żņżļĪŻ

┐▐4ĪĪGaN×æēäĪ╩├µ▒¹Ī╦ż╚żĮżņż“×æ║ŅżĘż┐3źżź¾ź┴ż╬GaNź”ź¦Ī╝źŽĪ╩║ĖĪ╦
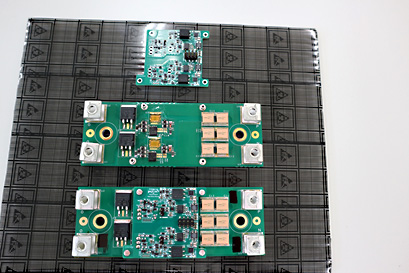
┐▐5ĪĪ╗Ņ║ŅżĘż┐GaNźčź’Ī╝ź╚źķź¾źĖź╣ź┐ż“╗╚ż├ż┐źŌźĖźÕĪ╝źļ┤łĘQ¹|
┐«═Ļ└Ł╗Ņ┘xżŌĮ¬ż©żŲż¬żĻĪó╣ŌčaĄšźąźżźóź╣╗Ņ┘xżŪżŽĪó150°CĪó1400VżŪ100╗■┤ųĪó24Ė─ż╬źŪźąźżź╣ż“źŲź╣ź╚żĘż┐ĪŻżĮż╬±T▓╠Īó1000╗■┤ųĖÕżŪżŌŽsżņż┐ź└źżź¬Ī╝ź╔żŽź╝źĒżŪżóż├ż┐ĪŻ
└«░µĢ■żŽĪųGaNżŽŲ³╦▄Ö┌ż▐żņż╬╚ŠŲ│öüż└ż½żķż│żĮĪóĪ╩║ŻżŽä▌╣±ż╬NavitasżõPower Integrationsż╦╔ķż▒żŲżżżļż¼Ī╦örżĻ╩ųżĘżŲżżżŁż┐żżĪūż╚żĮż╬ÕX┴Tż“ĖņżļĪŻ


