Ų³╬®×æ║ŅĮĻż¼MEMS▓─Ų░ŗż“¾H┴žŪ█└■ż╦└▀ż▒żļ1ź┴ź├źūCMOSź╗ź¾źĄĪ╝ż“╗Ņ║Ņ
¾H┴žŪ█└■Č\Įčż“╗╚żżĪóŪ█└■┴žŗ╩¼ż╦MEMS▓─Ų░ŗż“└▀ż▒żļż╚żżż”Īó1ź┴ź├źūČ\Įčż¼┼ąŠņżĘż┐ĪŻŲ³╬®×æ║ŅĮĻż╬├µ▒¹Ė”ē|ĮĻż¼CMOSźūźĒź╗ź╣ż╦īęČ©ż╣żļż│ż╚ż╩ż»MEMSż“ĮĖ└čżŪżŁżļźūźĒź╗ź╣ż“ŗī20övź▐źżź»źĒź▐źĘź¾/MEMS·tżŪ╚»╔ĮżĘż┐ĪŻ
MEMSź┴ź├źūż╬ŠW(w©Żng)┼└żŽ▓─Ų░ŗ╩¼ż¼Š«żĄżżż│ż╚ĪŻźŌź╬źĻźĘź├ź»żŪMEMSź╗ź¾źĄĪ╝ż╩ż╔ż╬▓─Ų░ŗ╩¼ż“║Ņżļż┐żßż╦żŽCMOSövŽ®ŖõżŪźūźĒź╗ź╣æųż╬īęČ©ż“żĘż╩ż▒żņżą║Ņ×æż¼žMżĘż½ż├ż┐ĪŻż│ż╬ż┐żßĪóMEMSź╗ź¾źĄĪ╝ż╚CMOS ICż“╠Ą═²ż╦źŌź╬źĻźĘź├ź»ż╦ĮĖ└čż╗ż║Īóź▐źļź┴ź┴ź├źūżŪ1źčź├ź▒Ī╝źĖż╦Ū╝żßżļźĘź╣źŲźÓźżź¾źčź├ź▒Ī╝źĖĪ╩SiPĪ╦ż¼╝ń╬«ż╦ż╩żĻż─ż─żóż├ż┐ĪŻżĘż½żĘĪó╩Ż┐¶ż╬ź┴ź├źūż“▓Żż╦╩┬ż┘ż┐żĻĪóāeż╦└čż¾ż└żĻżĘżŲżŌźčź├ź▒Ī╝źĖż╬źĄźżź║ż¼ź╚Ī╝ź┐źļż╬Įj(lu©░)żŁżĄż“»éżßżŲżżż┐ĪŻ
Ų³╬®×æ║ŅĮĻżŽCMOS ICźūźĒź╗ź╣ż“ż█ż▄żĮż╬ż▐ż▐╗╚ż©żļźūźĒź╗ź╣ż“│½╚»Īó¾H┴žŪ█└■ŗ╩¼ż╦MEMS▓─Ų░ŗ╩¼ż“└▀ż▒żļż│ż╚żŪĪó1ź┴ź├źūMEMSź╗ź¾źĄĪ╝ż“│½╚»żĘż┐ĪŻCMOSövŽ®żŪżŽövŽ®ŗ╩¼ż“?y©żn)æ║ŅżĘż┐ĖÕż╦ź└ź▐źĘź¾źūźĒź╗ź╣ż╩ż╔ż╦żĶż├żŲ¾H┴žż╬Ū█└■ż“Ę┴└«ż╣żļż’ż▒ż└ż¼Īóż│ż╬¾H┴žŪ█└■ŗ╩¼ż╦MEMS▓─Ų░ŗ╩¼ż“Ę┴└«żĘżŲżŌCMOSövŽ®ż╬└Łē”żŽ╩čż’żķż╩żżĪŻż│ż╬Č\Į迎Īó2Ī┴3┴žż╬Ū█└■┴žWĪóWSi║Ó╬┴żŪĘ┴└«żĘż┐ĖÕż╦ĪóĖ³żż└õ▒’┴žż╬▐kŗż“ż»żĻģsżżżŲȧ┤ųźŁźŃźėźŲźŻż“Ę┴└«ż╣żļż╚żżż”żŌż╬(┐▐1)ĪŻ
![Ū█└■MEMS╣Įļ]](/archive/editorial/technology/img/TFP090803-01a.jpg)
źŁźŃźėźŲźŻż╬Ę┴└«żŽ╝Īż╬żĶż”ż╦╣įż”ĪŻż▐ż║Īó▓╝ŗ┼┼Č╦ż“Ę┴└«żĘż┐ĖÕĪóĖ³żżSiO2┴žż“?q©▒)\└迥ż╗Ī󿥿ķż╦æųŗ┼┼Č╦ż“Ę┴└«ż╣żļĪŻæųŗ┼┼Č╦ż╦¾H┐¶ż╬ĘĻż“│½ż▒żŲż¬żŁĪóżĮż╬æųż½żķźūźķź║ź▐ź©ź├ź┴ź¾ź░żóżļżżżŽź”ź¦ź├ź╚ź©ź├ź┴ź¾ź░ż╩ż╔żŪæųŗ┼┼Č╦ż╬▓╝ż╬SiO2┴žż“║’ż├żŲżżż»ĪŻ┼┼Č╦ż╬ĘĻż╬Įj(lu©░)żŁżĄż╚ź©ź├ź┴ź¾ź░Š“°Pż╩ż╔żŪźŁźŃźėźŲźŻźĄźżź║ż¼»éż▐żļĪŻ║’żķżņżļĖ─Ī╣ż╬ĘĻż¼╝Īŗīż╦ż─ż╩ż¼ż├żŲżżżŁĪó║ŪĮ¬┼¬ż╦╣ŁżżČ§žÜż¼żŪżŁżļĪŻźŁźŃźėźŲźŻż╬Įj(lu©░)żŁżĄżŽź©ź├ź┴ź¾ź░Š“°Pż╚╗■┤ųżŪöU(ku©░)Ėµż╣żļż╚żĘżŲżżżļĪŻ
żŌż╚żŌż╚¾H┴žŪ█└■żŽźūźķź║ź▐CVDż╩ż╔450ĪŅ░╩▓╝ż╬źūźĒź╗ź╣żŪ╣įż”ż┐żßĪóMEMSŗ╩¼ż“║Ņżļ╣®µćż╚¾H┴žŪ█└■╣®µćż╚ż╬┐ŲŽ┬└ŁżŽ╬╔żżĪŻż│ż╬ȧžÜż“ŠW(w©Żng)├ōżĘżŲ¼ś┼┼═Ų╬╠źŁźŃźčźĘź┐ź¾ź╣ż╬╩č▓Įż╦żĶż├żŲ░Ą╬üż“ĖĪĮąż╣żļż╚żżż”░Ą╬üź╗ź¾źĄĪ╝ż“╗Ņ║ŅżĘż┐ĪŻ┐▐2ż╬╬ŃżŪżŽĪó50Ė─ż╬ź└źżźõźšźķźÓż“Ę┴└«żĘż┐Īó0.9mmĪ▀0.8mmż╬Š«żĄż╩░Ą╬üź╗ź¾źĄĪ╝żŪżóżĻĪóź└źżźõźšźķźÓż╬─ŠĘ┬ż“╩čż©żļż│ż╚żŪżżżĒżżżĒż╩░Ą╬ü╩č▓Įż╦×┤▒■żŪżŁżļĪŻ▓├ż©żŲĪóĖĪĮą┤Č┼┘żõ╗@┼┘żŽ50Ė─ż╬░Ą╬üź╗ź¾źĄĪ╝ż“┴╚ż▀╣ńż’ż╗żļż│ż╚żŪ─┤┼DżŪżŁżļĪŻ
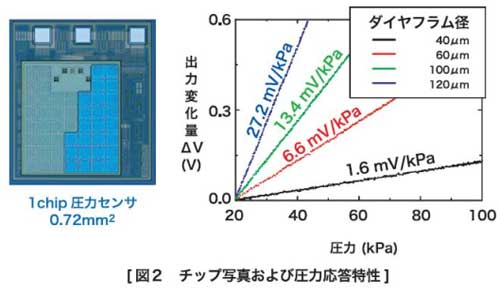
▐k╚╠┼¬ż╦MEMSż╩ż╔ż╬ź╗ź¾źĄĪ╝┐«ęÄ(gu©®)żŽźżź¾źįĪ╝ź└ź¾ź╣ż¼╣Ōżżż┐żßĪóź╬źżź║ż╬▒Ųūxż“£pż▒żõż╣żżż┐żßĪóź╗ź¾źĄĪ╝ż½żķż╬┐«ęÄ(gu©®)ż“żŌż├ż╚░Ężżżõż╣żż┐«ęÄ(gu©®)źņź┘źļż╦╩č┤╣ż╣żļĪŻżĮż╬ż┐żßż╬źóź¾źūżõźņź┘źļźĘźšź┐Ī╝ż╩ż╔ż╬övŽ®ż“1ź┴ź├źūż╦ĮĖ└čż╣żļĪŻ║ŻövżŽĪóCMOSövŽ®ż╚żĘżŲźóź¾źūż╩ż╔źóź╩źĒź░övŽ®ż└ż▒żŪ╣Į└«żĘż┐ż¼ĪóA-D╩č┤╣żĘżŲźŪźĖź┐źļ┐«ęÄ(gu©®)ĮĶ═²ż╣żļöĄ(sh©┤)╦ĪżŌżóżĻż”żļż╚Ų³╬®ż╬└Ō£½µ^żŽ┼·ż©ż┐ĪŻ

NEDOż╬Īų╣ŌĮĖ└čĪ”╩Ż╣ńMEMS×æļ]Č\Įč│½╚»Ą£Č╚Īūż╬ܦ▐qż“£pż▒żŲ│½╚»żĘż┐Īóż│ż╬Č\Į迎śOŲ░┘Zż╬ź┐źżźõ░ĄĖĪē¶(m©©ng)żõĪóŠūŲ═ĖĪē¶(m©©ng)Īó┐p░Ą╝ŖĪóȧ─┤ĄĪ▀_(d©ó)ż╩ż╔ż╦╗╚ż©żļż╚żĘżŲżżżļĪŻż▐ż┐ĪóŠ«Ę┐żŪżóżļż│ż╚ż“ØŖ─╣ż╚żĘżŲźĒź▄ź├ź╚ż╬╗ž└Ķż╬└▄┐©ź╗ź¾źĄĪ╝ż╚żĘżŲżŌ▓─ē”ż└ż╚żĘżŲżżżļĪŻżĄżķż╦Īó▐k╚╠ż╬CMOS LSIż╦ż¬żżżŲżŌĪóȧžÜźŁźŃźėźŲźŻżŽLow-k║Ó╬┴ż╚żĘżŲ╗╚ż”ż│ż╚żŌżóżĻż©żļĪŻ


