LEAPĪóLSIŠ├õJ┼┼╬ü║’žōż╬ż┐żßMOSż╬Ł∙Vt─ŃžōĪó╔įĦ╚»└ŁźßźŌźĻż╦╬ü┼└
LEAPĪ╩«Ć─Ń┼┼░ĄźŪźąźżź╣Č\ĮčĖ”ē|┴╚╣ńĪ╦ż¼2012 IEEE Symposia on VLSI Technology and Circuits (─╠Š╬VLSI Symposium)żŪ3°PżŌż╬éb╩Ėż“╚»╔ĮżĘż┐ĪŻŲ▒Ė”ē|┴╚╣ńżŽĪóź│ź¾źįźÕĪ╝ź┐źĘź╣źŲźÓż“éb═²övŽ®Īó1╝ĪźßźŌźĻĪó2╝ĪźßźŌźĻĪó│░ŗĄŁ▓▒ż╚╩¼ż▒żŲĪóżĮżņżŠżņż╬─ŃŠ├õJ┼┼╬üČ\Įčż╦ŲDżĻ┴╚ż¾żŪżżżļĪŻ
║ŻövVLSI SymposiumżŪ╚»╔ĮżĘż┐Č\Į迎Īóéb═²övŽ®żŪØŁ═ūż╩ź╩ź╬ź╚źķź¾źĖź╣ź┐╣Įļ]źūźĒźĖź¦ź»ź╚ż½żķĪó1)─Ń┼┼░ĄŲ░║Ņż“╣įż”ż╚żŁż╬ź▓Ī╝ź╚żĘżŁżż┼┼░ĄVtż╬źąźķż─żŁ─ŃžōĪó2)źĻź│ź¾źšźŻź«źÕźóźķźųźļźĒźĖź├ź»źŪźąźżź╣Ė■ż▒ż╬╔įĦ╚»└Łź╣źżź├ź┴Īó3)RAMż╚żĘżŲ╗╚ż©żļ╔įĦ╚»└ŁMĪ╩magneticĪ╦RAMĪóż╬3ż─żŪżóżļĪŻźßźŌźĻŗ╩¼żŽĪó2)Īó3)ż╚żŌ╔įĦ╚»└Łż“ź┐Ī╝ź▓ź├ź╚ż╚żĘĪóżĘż½żŌź╚źķź¾źĖź╣ź┐Ę┴└«ĖÕż╬¾H┴žŪ█└■ōļ░Ķż╬├µż╦3╝ĪĖĄ┼¬ż╦║ŅżĻ╣■żÓĪŻ2)żŽ“£═Ķż╬FPGAż╦╗╚ż’żņżŲżżżļSRAMź╣źżź├ź┴ż“╔įĦ╚»└ŁźßźŌźĻż╦ŲDżĻü÷ż©żŲFPGAż╬ź┴ź├źūĀC└čż“╝S┼¬ż╦žōżķżĮż”ż╚żżż”żŌż╬ĪŻ3)żŽĮ±żŁ┤╣ż©öv┐¶ż“10ż╬16ŠĶövĪ╩1»BövĪ╦░╩æųż╦╗\żõżĘżŲRAMż╚żĘżŲŲDżĻ░Ęż©żļżĶż”ż╦ż╣żļżŌż╬ĪŻ
ź╔Ī╝źčź¾ź╚źņź╣żŪVtźąźķż─żŁż“žōżķż╣
║ŪĮķż╬ź╚źķź¾źĖź╣ź┐ż╦ż¬żżżŲVtż╬źąźķż─żŁŁ∙Vtż“▓■║¤ż╣żļ═²ĮyżŽĪó╚∙║┘▓Įż╣żļż╦ż─żņź╚źķź¾źĖź╣ź┐ż╬Vtż╬źąźķż─żŁż¼ĮjżŁż»ż╩ż├żŲż»żļż┐żßż└ĪŻLEAPż╬ĮjźŲĪ╝ź▐żŪżóżļ─ŃŠ├õJ┼┼╬üČ\ĮčżŪżŽĪó┼┼░Ąż“▓╝ż▓żņżą▓╝ż▓żļż█ż╔LSIż╬Š├õJ┼┼╬üżŽ▓╝ż¼żļż¼ĪóVtż╬źąźķż─żŁżŽĮjżŁż»ż╩żļĪŻż╣żŪż╦MIRAIźūźĒźĖź¦ź»ź╚ż╦ż¬żżżŲĪó65nmź╚źķź¾źĖź╣ź┐ż“100╦³Ė─║Ņ×æżĘĪóżĮż╬źąźķż─żŁż╦ż─żżżŲ─┤ż┘ż┐ĪŻMOSź╚źķź¾źĖź╣ź┐żŪżŽĪó1╬®öĄź╗ź¾ź┴źßĪ╝ź╚źļ┼÷ż┐żĻ10ż╬24ŠĶĖ─ż╬źĘźĻź│ź¾ĖČ╗ęż╦Ų▒17ŠĶĖ─ż╬ź╔ź╩Ī╝żõźóź»ź╗źūź┐ż“Ų│Ų■ż╣żļŚlż└ż¼Īó╚∙║┘▓Įż¼┐╩żÓż╚Īó╬Ńż©żą30nm╬®öĄ┼÷ż┐żĻż╬ź╔ź╩Ī╝żõźóź»ź╗źūź┐ż╬┐¶żŽ┐¶10Ė─Ī┴┐¶100Ė─ż╚┐¶ż©żķżņżļźņź┘źļż╦ż╩żļĪŻ20nm╬®öĄżõ10nm╬®öĄ┼÷ż┐żĻż╚ż╩żļż╚Īóź╔Ī╝źūż╣żļź╔ź╩Ī╝żõźóź»ź╗źūź┐ż╬┐¶ż¼ŠņĮĻż╦żĶż├żŲż’ż║ż½ż╦░█ż╩żļż╚żżż”▒Ųūxż“ĮjżŁż»£pż▒żļĪŻż│ż╬ż┐żßĪóMOSż╬ØŖ└ŁżŽĮjżŁż»║ĖīÜżĄżņżļż│ż╚ż╦ż╩żļĪŻ
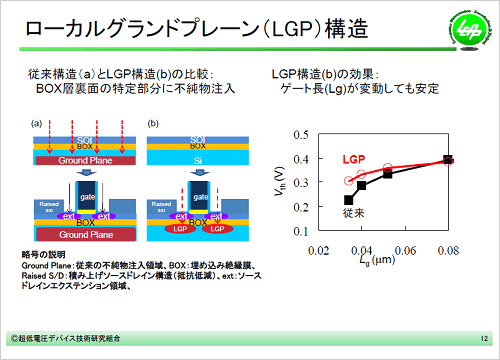
┐▐1ĪĪź╔Ī╝źčź¾ź╚źņź╣żŪVtźąźķż─żŁż“žōżķżĘż┐─Ń┼┼░ĄSOIź╚źķź¾źĖź╣ź┐ĪĪĮąųZĪ¦LEAP
║ŻövĪóLEAPż¼│½╚»żĘż┐ź╚źķź¾źĖź╣ź┐(┐▐1)żŽĪóź╔ź╩Ī╝żõźóź»ź╗źūź┐ż╬Ū╗┼┘ż“Č╦╬üžōżķżĘż┐ź╔Ī╝źčź¾ź╚źņź╣ż╬SOI╣Įļ]ż“║╬├ōżĘĪóVtöUĖµż“ź▓Ī╝ź╚źßź┐źļż╬╗┼Ą£┤ž┐¶║╣ż╚┤łźąźżźóź╣żŪ╣įż”żŌż╬ĪŻ┤ł┼┼░╠ż“╔w─Ļż╣żļż┐żßż╦┤ł¤©▓Į╦ņż╬▓╝ż╦┐╝ż»ź╔ź╩Ī╝/źóź»ź╗źūź┐╔įĮŃرōļ░Ķż“Ę┴└«ż╣żļŚlż└ż¼Īóź╚źķź¾źĖź╣ź┐ōļ░Ķµ£öüż╦æ]ż┴╣■żÓż╚┤¾Ö┌═Ų╬╠ż¼╗\▓├ż╣żļż┐żßĪóź╔źņźżź¾Ī”źĮĪ╝ź╣Ŗõ╩╔ż╬▓╝ż╬┐╝żż┤łŗ╩¼ż└ż▒ż╦Ę┴└«żĘż┐ĪŻż│żņż“LGPĪ╩źĒĪ╝ź½źļź░źķź¾ź╔źūźņĪ╝ź¾Ī╦ż╚Ō}ż¾żŪżżżļĪŻ
żŪź╔źņźżź¾┼┼╬«ż╬źąźķż─żŁż¼žōŠ»ĪĪĮąųZĪ¦LEAP](/archive/editorial/technology/img/TFP120615-01b.gif)
┐▐2ĪĪ┐ĘSOI╣Įļ](īÜż╬ź░źķźš)żŪź╔źņźżź¾┼┼╬«ż╬źąźķż─żŁż¼žōŠ»ĪĪĮąųZĪ¦LEAP
żĮż╬±T▓╠Īóø]ź┴źŃź═źļĖ·▓╠żŽžōżĻ(┐▐1)ĪóVtż╬źąźķż─żŁżŌžōŠ»żĘż┐Ī╩┐▐2Ī╦ĪŻ
┐ĘĘ┐FPGAĖ■żŁż╬╔įĦ╚»└Łź╣źżź├ź┴
2╚ųų`ż╬FPGAż╦╗╚ż”╔įĦ╚»└ŁźßźŌźĻź╣źżź├ź┴żŪżŽĪóŲ╝źżź¬ź¾ż╬┼┼Ąż▓Į│ž╚┐▒■ż“ŠW├ōż╣żļ(┐▐3)ĪŻĮ±żŁ┤╣ż©öv┐¶żŽ1000övµć┼┘ż╚Š»ż╩żżż¼ĪóFPGAż╬övŽ®Ū█└■ż╬źūźĒź░źķźÓż╦żŽØ▓╩¼ż╩ØŖ└Łż└ĪŻż│ż╬ź╣źżź├ź┴żŽŲ╝Ī╩CuĪ╦┼┼Č╦ż╚źļźŲź╦ź”źÓĪ╩RuĪ╦┼┼Č╦ż¼PSEĪ╩ź▌źĻź▐Ī╝╔wöü┼┼▓“ä®Ī╦ż“Č┤ż¾ż└╣Įļ]ż“Ęeż─ĪŻCu┼┼Č╦ż╦┘ć┼┼░Ąż“▓├ż©żļż╚Cuźżź¬ź¾ż¼CuČ╦ż½żķĮą╗ŽżßĪóPSEŲŌż╦Cuż¼└ŽĮążĘżŲżżżŁĪóżĘż▐żżż╦żŽRu┼┼Č╦ż╚ż─ż╩ż¼żĻ┼┼╬«ż¼╬«żņżļĪŻCu┼┼Č╦ż╦╔ķ┼┼░Ąż“ż½ż▒żļż╚└ŽĮążĘż┐Cuż¼źżź¬ź¾▓ĮżĘżŲCu┼┼Č╦żž╠ßż├żŲżżżŁĪó╬Š┼┼Č╦┤ųż¼▀`żņżŲżĘż▐żżź¬źšėX▌åż╦ż╩żļĪŻ
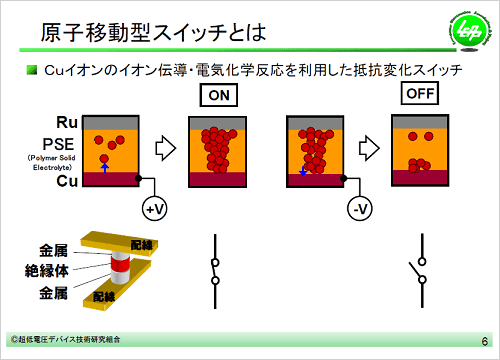
┐▐3ĪĪŪ█└■ōļ░Ķż╦║ŅżĻ╣■żßżļ╔įĦ╚»└Łź╣źżź├ź┴ĪĪĮąųZĪ¦LEAP
ż│ż╬2├╝╗ęź╣źżź├ź┴ż“─Šš`ż╦ĄšĖ■żŁż╦└▄¶öżĘżŲ3├╝╗ę┴Ū╗ęż╚żĘż┐ĪŻ┐▐4ż╬├╝╗ęT1ż▐ż┐żŽT2ż╦×┤żĘżŲĪóöUĖµ├╝╗ęCż╦╔ķ┼┼░Ąż“ż½ż▒żļż╚Cuźżź¬ź¾ż¼╬«żņżŲżżżŁźūźĒź░źķźÓ┼┼╬«ż¼╬«żņżļĪŻöUĖµ├╝╗ęCż╦Ąš┼┼░Ąż“═┐ż©żļż╚ĪóCuźżź¬ź¾ż¼Cu┼┼Č╦Ŗõż╦öĪŲ░żĘĪóCuż╚öUĖµ┼┼Č╦┤ųż╦┼┼╬«ż¼╬«żņż╩ż»ż╩żļĪŻźūźĒź░źķźÓėX▌åż“Ė½żļż╬ż╦żŽT1ż╚T2┤ųż╦┼┼░Ąż“ż½ż▒Īó┼┼╬«ż¼╬«żņżļż½ż╔ż”ż½ż“ĖĪĮąż╣żļĪŻ
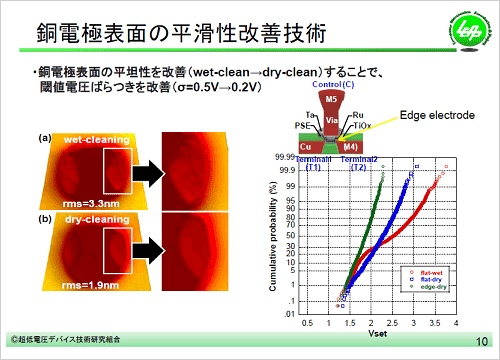
┐▐4ĪĪ4┴žų`Ū█└■ż╚5┴žų`Ū█└■żŪ║Ņżļ3├╝╗ę╔įĦ╚»└Łź╣źżź├ź┴ĪĪĮąųZĪ¦LEAP
║ŻövĪóŗī4┴žż╬Cu┼┼Č╦ż╬│čż╦ż¬ż▒żļ┼┼─cĮĖ├µż“└čČ╦┼¬ż╦ŠW├ōżĘĪóźūźĒź░źķźÓ┼┼░Ąż““£═Ķż╬2.27Vż½żķ1.87Vżžż╚▓╝ż▓żļż│ż╚ż¼żŪżŁż┐ĪŻżĄżķż╦Cu╔ĮĀCż╬╩┐┘Q└Łż“▓■║¤żĘżŲźūźĒź░źķźÓ┼┼░Ąż╬źąźķż─żŁż“žōżķżĘż┐ĪŻ╩┐┘Q└Łż“▓■║¤ż╣żļż┐żßż╦“£═Ķż╬ź”ź¦ź├ź╚¹ÉŠ¶ż“ź╔źķźż¹ÉŠ¶ż╦ü÷ż©ż┐Ī╩┐▐4Ī╦ĪŻż│ż╬ż│ż╚ż╦żĶżĻĪó╔ĮĀCż╬▒·õüżŽrmsĪ╩źļĪ╝ź╚Ų¾ŠĶ╩┐ČčĪ╦żŪ3.3nmż½żķ1.9nmż╚žōŠ»żĘż┐ĪŻ
▓├ż©żŲĪóCu╔ĮĀCż╬¤©▓Įż“╦╔ż░ż┐żßż╬źąź├źšźĪźßź┐źļ┴žż╬ź┴ź┐ź¾¤©▓Į╦ņż╬¤©▓Įż¼╔įØ▓╩¼ż└ż╚ź┴ź┐ź¾źßź┐źļż¼╗─żĻźĻĪ╝ź»┼┼╬«╗\▓├ż╬ĖČ░°ż╚ż╩żļĪŻż│ż╬ż┐żßĪóźūźĒź╗ź╣Š“°Pż“╩čż©Īóź┴ź┐ź¾ż╬Ė³żĄż““£═Ķż╬1nmż½żķ0.5nmż╦Ū÷╦ņ▓ĮżĘź┴ź┐ź¾ż“Ø▓╩¼ż╦¤©▓ĮżĘż┐ĪŻ
1»Bövż╬Į±żŁ┤╣ż©ż“╝┬ĖĮżĘż┐STT MRAM
3°Pų`ż╬éb╩ĖżŽĪóĮ±żŁ┤╣ż©öv┐¶ż╦öU╠¾ż╬ż╩żżRAMŲ░║Ņż“┴└ż├ż┐╣ŌÅ]ż╬╔įĦ╚»└ŁMRAMżŪżóżļĪŻż│żņżŽĪóźūźĒź╗ź├źĄż¼ŲŌē┼żĄżņżŲżżżļ┴╚ż▀╣■ż▀źĘź╣źŲźÓLSIżŪżŽĪóźņźĖź╣ź┐żõFIFOĪ󟣟џ├źĘźÕż╩ż╔źßźŌźĻż╬žéżßżļ│õ╣ńż¼╣Ōż»ĪóĮŃ┐Ķż╩źķź¾ź└źÓźĒźĖź├ź»ż╬ŗ╩¼żŽżÓżĘżĒžōż├żŲżżżļż│ż╚ż╦ÅŚ░°ż╣żļĪŻźĘź╣źŲźÓLSIżŪżŽSRAMż“╗╚ż├żŲżżżļż│ż╚ż¼¾HżżĪŻżĘż½żĘĪóCMOS SRAMż╬Š├õJ┼┼╬üżŽŠ«żĄżżż╚żŽżżż©ĪóźĻĪ╝ź»┼┼╬«ż¼żóżĻĪó┼┼░ĄżŽŠ’ż╦ż½ż½ż├żŲżżżļĪŻ╔įĦ╚»└ŁźßźŌźĻżŽĪóźßźŌźĻż╦ż½ż½żļ┼┼Ė╗┼┼░Ąż“└┌ż├żŲżŌźßźŌźĻŲŌ═Ųż¼Š├ż©ż╩żżż┐żßĪóźßźŌźĻŗ╩¼ż╬Š├õJ┼┼╬üżŽź╝źĒż╦ż╩żļĪŻ
LEAPż¼Š}²Xż▒żŲżżżļż╬żŽSTTĪ╩spin transfer torqueĪ╦MRAMż╚Ō}żążņżļ╔įĦ╚»└ŁźßźŌźĻżŪżóżļĪŻ║ŻövĪóMRAMż╬Į±żŁ┤╣ż©öv┐¶ż¼ż█ż▄╠ĄĖ┬ż╚żŌżżż©żļ10ż╬16ŠĶövĪ╩1»BövĪ╦ż╚żżż”źŪĪ╝ź┐ż“įuż┐(┐▐5)ĪŻż│żņżŽĪóĮ±żŁ┤╣ż©┼┼░Ąż╬▓├Å]╗Ņ┘xż╬±T▓╠ĪóĮ±żŁ┤╣ż©┼┼░Ąż“║ŪĮj0.65VĪóŲ╔ż▀ĮążĘ┼┼░ĄżŽ0.2Ī┴0.3VżŪŲ░║Ņż╣żļż╚żĘżŲżŌ1»BövżŌż╬Į±żŁ┤╣ż©ż¼▓─ē”żŪżóżļĪŻ
![┐▐5ĪĪ┼┼░Ą▓├Å]╗Ņ┘xż╦żĶżĻ1»Bövż╬Į±żŁ┤╣ż©öv┐¶ż“╝┬ĖĮĪĪĮąųZĪ¦LEAP](/archive/editorial/technology/img/TFP120615-01e.gif)
┐▐5ĪĪ┼┼░Ą▓├Å]╗Ņ┘xż╦żĶżĻ1»Bövż╬Į±żŁ┤╣ż©öv┐¶ż“╝┬ĖĮĪĪĮąųZĪ¦LEAP
STT MRAMż╬źßźŌźĻź╗źļżŽĪóź╣źżź├ź┴ź¾ź░├ōż╬źĘźĻź│ź¾MOSź╚źķź¾źĖź╣ź┐ż╚ĄŁ▓▒ŗż╚ż╩żļMTJĪ╩magnetic tunnel junctionĪ╦ż½żķż╩żļ(┐▐6)ĪŻMTJżŽMgOź╚ź¾ź═źļ¤©▓Į╦ņż╬╬ŠĀCż“Ų¾ż─ż╬CoFeB╝¦▓Į┴žżŪźĄź¾ź╔źżź├ź┴żĘż┐╣Įļ]ż“ż╚żļĪŻ╝¦▓Į┴žż╬▐kż─ż“╔w─Ļ┴žż╚żĘĪóżŌż”▐köĄż╬╝¦▓Į┴žż“Īóź╣źįź¾ż╬Ė■żŁż“╩čż©żķżņżļźšźĻĪ╝┴žż╚ż╣żļĪŻŲ¾ż─ż╬╝¦▓Į┴žź╣źįź¾ż¼Ų▒żĖĖ■żŁż└ż╚─Ń°BŃ^ĪóĄšĖ■żŁżŽ╣Ō°BŃ^ż╦ż╩żļż│ż╚ż“ŠW├ōżĘżŲ1Īó0ż“ČĶ╩╠ż╣żļĪŻ╝¦▓Įż“╣Ō°BŃ^ėX▌åż╦źūźĒź░źķźÓż╣żļ╗■żŽĪó╔w─Ļ┴žż½żķźšźĻĪ╝┴žż╦Ė■ż▒żŲĮj┼┼╬«ż“╬«żĘĪó─Ń°BŃ^ėX▌åż╦żŽżĮż╬ĄšĖ■żŁż╦┼┼╬«ż“╬«ż╣ĪŻ
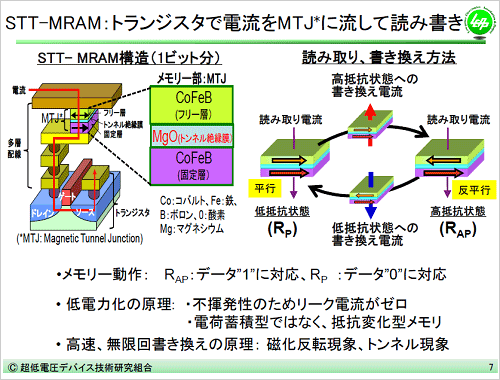
┐▐6ĪĪSTT MRAMż╬Ų░║ŅĖČ═²ĪĪĮąųZĪ¦LEAP
║ŻövĪóĮ±żŁ┤╣ż©öv┐¶ż“1»Bövż╦żŌ╗\żõż╣ż│ż╚ż¼żŪżŁż┐ż╬żŽĪóMTJż╬±TŠĮ└Łż“▓■║¤żĘż┐ż│ż╚ż╦żĶżļĪŻż│żņż▐żŪMTJż“Ę┴└«ż╣żļŠņ╣ńĪóźóźŌĪ╝źšźĪź╣ż╬CoFeB┴žż╬æųż╦±TŠĮ└Łż╬MgOż“ī\└čżĘĪ󿥿ķż╦źóźŌĪ╝źšźĪź╣ż╬CoFeBźšźĻĪ╝┴žż“Ę┴└«żĘżŲżżż┐ĪŻżĘż½żĘĪóMgOżŽźóźŌĪ╝źšźĪź╣ż╬æųż╦Ę┴└«ż╣żļż┐żß±TŠĮ└Łż¼ĄKżżĪŻż│żņżķż╬╦ņż“ī\└čżĘż┐ĖÕż╦źóź╦Ī╝źļżĘżŲżŌMgOżŽź░źņźżź¾ż¼ĮĖż▐żļ¾H±TŠĮż╦żĘż½ż╩żķż╩ż½ż├ż┐ĪŻżĮż│żŪĪóźóźŌĪ╝źšźĪź╣CoFeBż╬æųż╦±TŠĮ└Łż╬CoFe┴žż“Ū÷ż»Ę┴└«żĘĪóżĮż╬ĖÕMgOż“Ę┴└«ż╣żļż╚CoFe┴žż╬±TŠĮż╬Ė■żŁż╦öĄĖ■└Łż¼┬Ęż”żĶż”ż╦ż╩ż├ż┐ĪŻźšźĻĪ╝┴žĘ┴└«ĖÕż╦źóź╦Ī╝źļĮĶ═²ż“╣įż”ż╚ĪóCoFe±TŠĮż╦▐pż├żŲMgOżĄżķż╦żŽĪóźšźĻĪ╝┴žż╬CoFeB┴žż▐żŪż¼▓╝├Žż╬Ė■żŁż╦▐pż├żŲ±TŠĮ└Łż¼╬╔ż»ż╩ż├ż┐ĪŻ
║Żövż╬MTJż╬éāĀCż“TEMĪ╩Ų®āįĘ┐┼┼╗ęĖ▓╚∙¬ÜĪ╦żŪĖ½żļż╚CoFeBĪóCoFeĪóMgOĪóCoFeBż╬ČŁ─cż¼żŽż├żŁżĻż“Ė½ż©ż┐ĪŻĮ±żŁ┤╣ż©öv┐¶ż╬▓├Å]╗Ņ┘xżŽĪóĪ▐0.5V░╩▓╝ż╬┼┼░ĄżŪĮ±żŁ╣■ż▀żŪżŁżļż╚żżż”Ą£╝┬ż“ĖĄż╦Īó╝╝čażŪ0.7VĪó0.8VĪó0.9Vż╚┼┼░Ąż“▓├Å]żĘż┐ĪŻŪ╦Žsż╦╗Ļżļż▐żŪż╬Į±żŁ┤╣ż©öv┐¶ż“źūźĒź├ź╚żĘżŲ0.65VżŪżŽ10ż╬16ŠĶövż╚żżż”Ė½└čżŌżĻż“įuż┐ĪŻ0.6VżŪż╬Į±żŁ┤╣ż©ż└ż╚10ż╬18ŠĶövż╦ż╩żļĪŻ


