OSAT2░╠ż╬Amkorż¼1░╠ż╬ASEż╦¶öżŁŲ³╦▄ż╦Ė”ē|│½╚»Ą“┼└ż“└▀Åø
OSATĪ╩╚ŠŲ│öüĖÕ╣®µćż╬×æļ]æą╔ķČ╚ŪvĪ╦└ż─c2░╠ż╬ä▌Amkor Technologyż¼╩ĪŃK▌xż╦Ė”ē|│½╚»Ą“┼└ż“└▀ż▒żļż╚╚»╔ĮżĘż┐ĪŻAIĖ■ż▒ź┴ź├źūż╬╝┬äóż╦└Ķ├╝źčź├ź▒Ī╝źĖż¼╗╚ż’żņżŲż¬żĻĪó└Ķ├╝źčź├ź▒Ī╝źĖż“ĮõżļŲ░żŁżŽŚ„żĘżżĪŻä▌Applied MaterialsżŽźĘź¾ź¼ź▌Ī╝źļżŪ└Ķ├╝źčź├ź▒Ī╝źĖż╬Ė”ē|│½╚»ż“äė▓Įż╣żļĪŻ└Ķ├╝źčź├ź▒Ī╝źĖź¾ź░ż½żķźčź’Ī╝╚ŠŲ│öüżŌź½źąĪ╝żŪżŁżļźŌĪ╝źļź╔äóÅøż“źóźįź├ź»źõź▐ź└ż¼│½╚»żĘż┐ĪŻ
║Żövż╬Amkorż╬┐╩ĮążŽĪó║ŻŃQż╬7ĘŅ31Ų³ż╦OSAT║ŪĮjŠ}ż╬±śŽčASEż╚╩ĪŃKĖ®Ē×ČÕä”▌xż¼▌xŃ~├Ž╠¾16źžź»ź┐Ī╝źļż“34▓»▀ģżŪŲDįuż╣żļ▓ŠĘ└╠¾ż“─∙±TżĘż┐ż│ż╚ż╦¶öż»ĪóŲ³╦▄żŪż╬OSATż╬īÖ└Ł▓Įż╦ż╩żļĪŻAmkorżŽĪóŲ³╦▄Įķż╬Ė”ē|│½╚»Ą“┼└ż“2025ŃQ4ĘŅż╦╩ĪŃK▌xż╦└▀ż▒żļż╚żĘż┐ĪŻĄ“┼└żŽ▌xŲŌż╬źėźļż╦ÅøżŁĪóżĮż╬╣ŁżĄżŽ1063╩┐ä▌żŪĪóżĮż╬╚Š╩¼ż“ź»źĻĪ╝ź¾źļĪ╝źÓż╚ż╣żļĪŻAmkorż╬┐ĘĄ“┼└żŪżŽĪó┼┼╬üöUĖµż╦ż─ż½ż”źčź’Ī╝źŌźĖźÕĪ╝źļĪ╩╩Ż╣ńŗēäĪ╦żõźżźßĪ╝źĖź╗ź¾źĄĪ╝ż╚żżż├ż┐ĪóśOŲ░┘ZĖ■ż▒╚ŠŲ│öüż╬ĖÕ╣®µćż╬└Ķ├╝Č\Įčżõ╬╠ŠÅČ\ĮčĪó║Ó╬┴ż╦┤žż╣żļ┤┴├│½╚»ż╩ż╔ż“Š}²Xż▒żļĪóż╚11ĘŅ29Ų³ż╬Ų³╦▄Ęą║č┐Ę╩╣ż¼╩¾żĖż┐ĪŻ
ASEżŽż╣żŪż╦2004ŃQż╦NECæčĘ┴╣®Šņż“āA╝²żĘŠ}ż╦Ų■żņĪóÖ┌ŠÅż“¶öż▒żŲżżżļĪŻ7ĘŅ¼Źż╬ASEźĖźŃźčź¾ż¼Ę└╠¾ż╬╝ńöüżŪżóżĻĪóASEżŽŲ³╦▄żŪÖ┌ŠÅż“╣Łż▓żŲżżż»ż│ż╚ż¼▒«ż©żļĪŻAmkorżŽĮj╩¼Ė®ż╬├ń├½ź▐źżź»źĒźŪźąźżź╣ż¼┼ņėøĪóAmkorż╬½@╦▄ż“Ų■żņżŲJźŪźąźżź╣ż╚ż╩żĻĪó12ŃQż╦żŽ╔┘╗╬─╠ź╗ź▀ź│ź¾ź└ź»ź┐Ī╝Īó13ŃQż╦źļź═źĄź╣ź©źņź»ź╚źĒź╦ź»ź╣ż½żķżŌĖÕ╣®µćĄ“┼└ż“āA╝²żĘĪó15ŃQż╦Amkorż╬Ą“┼└ż╚ż╩ż├ż┐ĪŻČ”ż╦ĖÕ╣®µćż╬Ö┌ŠÅĄ“┼└ż“Ų³╦▄ż╦Ęeż├żŲżżżļż¼Īó└Ķ├╝źčź├ź▒Ī╝źĖĖ”ē|│½╚»Ą“┼└żŽĘeż├żŲżżż╩ż½ż├ż┐ż┐żßĪóżĮż╬║Ó╬┴│½╚»ż╦äėżżŲ³╦▄┤ļČ╚ż╚ż╬ź│źķź▄ż“ĄßżßżŲ║Żövż╬│½╚»Ą“┼└ż╚ż╩ż├ż┐ĪŻ
└Ķ├╝źčź├ź▒Ī╝źĖżŽAI░╩│░ż╦żŌĪó╣Ō└Łē”ź│ź¾źįźÕĪ╝źŲźŻź¾ź░Č\Įčż╦’Lż½ż╗ż╩żżż┐żßĪóSoCź┴ź├źūĪ▄╝■╩šźßźŌźĻ╣Į└«żŽNvidiaż╬AIź┴ź├źūż└ż▒żŪżŽż╩ż»ĪóAppleż╬M1~4źūźĒź╗ź├źĄż╬╝┬äóż╦żŌŲ▒══ż╩źčź├ź▒Ī╝źĖź¾ź░ż“├ōżżżŲżżżļĪŻż┐ż└żĘĪóM1Ī┴4źūźĒź╗ź├źĄżŽHBMżŪżŽż╩ż»DDR DRAMżŪżŽżóżļż¼Īóź┴ź├źū+╝■╩šźßźŌźĻ╣Į└«żŽ╣Łż¼żĻż─ż─żóżļĪŻ
└Ķ├╝źčź├ź▒Ī╝źĖżŽĪóĖÕ╣®µćż╚żŽ░ŃżżĪóTSVČ\Įčżõ2.5D/3D-ICČ\Įčż“żšż¾ż└ż¾ż╦╗╚żżĪó«Ć╣ŌĮĖ└čż╩ICż“×æļ]ż╣żļĪŻźŌź╬źĻźĘź├ź»żŪż╬ĮĖ└č┼┘żĶżĻżŌ╣ŌżżĮĖ└č┼┘ż╬ICż“─Ńź│ź╣ź╚żŪ╝┬ĖĮż╣żļČ\Įčż╚żĘżŲÅRų`żĄżņżŲżżżļĪ╩Š▄║┘żŽĪóSPIźšź®Ī╝źķźÓĪųź┴ź├źūźņź├ź╚Īó└Ķ├╝źčź├ź▒Ī╝źĖČ\Įčż╚żĮż╬╠ż═Ķ(II)Īūż“╗▓Š╚Ī╦ĪŻ
Øi╣®µćż╬×æļ]äóÅøäóÅøĮjŠ}ĪóApplied MaterialsżŽĪóĪųźĘź¾ź¼ź▌Ī╝źļ▓╩│žČ\ĮčĖ”ē|─ŻĪóźĘź¾ź¼ź▌Ī╝źļ╣±╬®Įj│žĪóŲŅ═╬═²╣®Įj│žż╩ż╔ż╚Ė”ē|│½╚»żŪČ©Č╚ż╣żļż│ż╚żŪ│ąĮ±ż“Ė“ż’żĘż┐ĪŻźņźŠź╩ź├ź»Ī”ź█Ī╝źļźŪźŻź¾ź░ź╣ĪóIntelĪóTSMCż╩ż╔ż╬äōŗż╚źĘź¾ź¼ź▌Ī╝źļżŪ▓±╣ńżĘĪóČ©Č╚ż╬öĄ╦Īż“ŲżĄ─żĘż┐ĪūĪóż╚27Ų³ż╬Ų³Ęąż¼╩¾żĖż┐ĪŻźĘź¾ź¼ź▌Ī╝źļżŪżŽ└Ķ├╝źčź├ź▒Ī╝źĖż╬ź╣ź┐Ī╝ź╚źóź├źūĪóSilicon Box╝ęż¼┴ÓČ╚żĘ╗ŽżßżŲż¬żĻĪóØi╣®µćż└ż▒żŪżŽż╩ż»└Ķ├╝źčź├ź▒Ī╝źĖż╬źżź¾źšźķż¼┼Dż©ż─ż─żóżļĪŻ
╚ŠŲ│öüź┴ź├źūż“źūźķź╣ź┴ź├ź»█`╗ķżŪ╔§┘Vż╣żļĪóźŌĪ╝źļźŪźŻź¾ź░äóÅøż╬źóźįź├ź»źõź▐ź└żŽĪó└Ķ├╝źĒźĖź├ź»ż½żķźßźŌźĻĪóżĮżĘżŲSiCźčź’Ī╝╚ŠŲ│öüż╬█`╗ķ╔§┘Vż╦żŌ╗╚ż©żļ┐ĘĘ┐źŌĪ╝źļź╔äóÅøĪųMS-RĪūż“╚»ŪõżĘż┐ĪŻż│ż╬äóÅøżŽĪó“£═Ķż╬ź╚źķź¾ź╣źšźĪźŌĪ╝źļź╔ż└ż▒żŪżŽż╩ż»└Ķ├╝źčź├ź▒Ī╝źĖ├ōż╬ź│ź¾źūźņź├źĘźńź¾źŌĪ╝źļź╔żõĪ󟎟żźųźĻź├ź╔ź▄ź¾źŪźŻź¾ź░Īóźčź’Ī╝╚ŠŲ│öüż╬źĘź¾ź┐źĻź¾ź░└▄╣ńż╦żŌ╗╚ż©żļźšźņźŁźĘźųźļż╩ź▐źĘź¾ż╚ż╩ż├żŲżżżļĪ╩┐▐1Ī╦ĪŻ
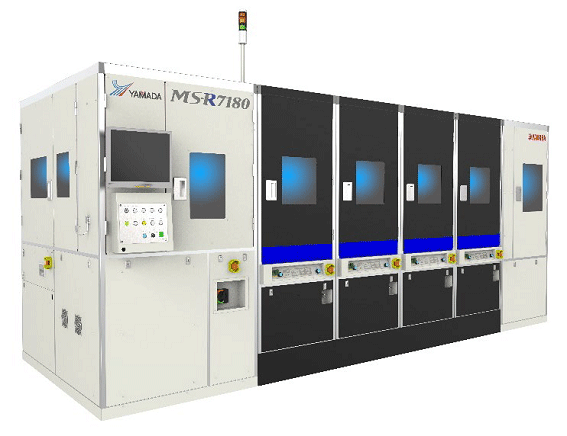
┐▐1ĪĪźóźįź├ź»źõź▐ź└ż╬ź╚źķź¾ź╣źšźĪĪ╝└«Ę┐ż╚ź│ź¾źūźņź├źĘźńź¾└«Ę┐ż¼▓─ē”ż╩źŌĪ╝źļź╔äóÅøĪĪĮąųZĪ¦źóźįź├ź»źõź▐ź└
ź╚źķź¾ź╣źšźĪĪ╝└«Ę┐ż╚ź│ź¾źūźņź├źĘźńź¾└«Ę┐ż╬źūźĒź╗ź╣ż╬╩čśŗż╩ż╔ż“1±śż╬äóÅøĪ╩źūźķź├ź╚źšź®Ī╝źÓĪ╦żŪ×┤▒■ż╣żļĪŻ█`╗ķ╬«Ų░źĘź▀źÕźņĪ╝źĘźńź¾▓“└Žż╦żĶż├żŲČŌĘ┐ż“└▀╝ŖżĘżŲż¬żĻĪó╣Ō╣õ└ŁČŌĘ┐ź┘Ī╝ź╣źµź╦ź├ź╚ż╚╣Ō╗@┼┘╣Ō░Ąź»źķź¾źūČŌĘ┐źµź╦ź├ź╚ż“┐Ę│½╚»żĘż┐ĪŻ└Ķ├╝źčź├ź▒Ī╝źĖżŪż╬ź┴ź├źūźņź├ź╚ż╬└č┴žż╦żŌČ╣Š«ż╩ź«źŃź├źūż╦ź▄źżź╔źņź╣żŪČč▐kż╦█`╗ķż“Į╝┼ČżĄż╗żļż│ż╚ż¼żŪżŁżļż╚żżż”ĪŻ


