SamsungźšźĪź”ź¾ź╔źĻż╚Amkorż¼2.5Dźčź├ź▒Ī╝źĖČ\Įčż“Č”Ų▒│½╚»
Samsungż╬źšźĪź”ź¾ź╔źĻŗ╠ńż¼║ŪĮj6Ė─ż╬HBMĪ╩High Bandwidth MemoryĪ╦źßźŌźĻż╚źūźĒź╗ź├źĄżõSoCż“2.5DĪ╩2.5╝ĪĖĄĪ╦żŪĮĖ└čż╣żļźčź├ź▒Ī╝źĖź¾ź░Č\Įčż“Amkorż╚Č”Ų▒żŪ│½╚»żĘż┐ĪŻ╚ŠŲ│öüźµĪ╝źČĪ╝ż¼źŪĪ╝ź┐ź╗ź¾ź┐Ī╝żõAIĪóHPCĪ╩╣Ō└Łē”ź│ź¾źįźÕĪ╝źŲźŻź¾ź░Ī╦Īóź═ź├ź╚ź’Ī╝ź»×æēäżž╗▓Ų■ż╣żļż╬ż“ܦ▐qż╣żļĪŻ
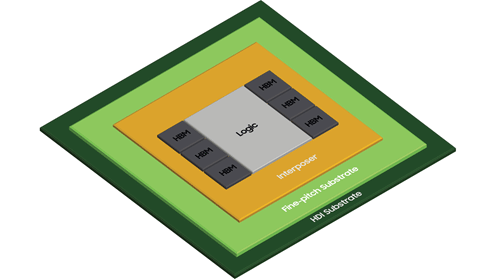
┐▐1ĪĪHBMż“║ŪĮj6Ė─ż▐żŪ┼ļ║▄żŪżŁżļźŽźżź©ź¾ź╔SoCźčź├ź▒Ī╝źĖź¾ź░Č\ĮčĪĪĮąųZĪ¦Samsung
║ŪŖZż╬źŽźżź©ź¾ź╔ź│ź¾źįźÕĪ╝ź┐Ė■ż▒ź┴ź├źūżŽĪó4Ė─ż╬HBMż“źżź¾ź┐Ī╝ź▌Ī╝źČæųż╦ĮĖ└čżĘż┐×æēäż¼¾Hż»ĪóAppleż╬ MacBookż╬CPUż╚ż╩żļź┴ź├źūżõĪóNokiaż╬ź═ź├ź╚ź’Ī╝ź»źūźĒź╗ź├źĄĪóAMDż╬ź┴ź├źūźņź├ź╚ŠW├ōż╬źūźĒź╗ź├źĄż╩ż╔Ė«╩┬ż▀ĪóSoCż“├µ┐┤ż╦Ū█ÅøżĘĪóżĮż╬╝■░Žż╦HBMż“Åøż»ż╚żżż”╣Į└«ż¼╗\ż©żŲżżżļĪŻSoCż╦żŽCPUż╚GPUż¼ĮĖ└迥żņżŲżżżļż┐żßĪóżĮżņżķż╬źŪĪ╝ź┐źßźŌźĻż“HBMżŪČ”Ń~żŪżŁĪóźĘź╣źŲźÓÅ]┼┘ż¼│╩├╩ż╦æųż¼żļż╚żżż”źßźĻź├ź╚ż¼żóżļż½żķż└ĪŻ
AppleżõNokia ż╬ź┴ź├źūżŪżŽHBMż¼4Ė─ż╬╣Į└«ż└ż├ż┐ż¼Ī╩╗▓╣═½@╬┴1Īó2Ī╦ĪóSamsungż╚Amkorż╬ź░źļĪ╝źūżŽ║ŪĮj6Ė─ż▐żŪ┼ļ║▄żŪżŁżļż│ż╚ż“┴╩ĄßżĘżŲżżżļĪŻ
Samsungż¼H-CubeĪ╩Hybrid-Substrate CubeĪ╦ż╚Ō}żųż│ż╬Č\Į迎ĪóCPUż╚GPUż╩ż╔ż╬┬Šż╬źūźĒź╗ź├źĄż“ĮĖ└čżĘż┐SoCżŪżŽĪóCPUż╚GPUż╬źßźŌźĻż“Č”Ń~żĘżŲżżżļöĄż¼ĪóżĘżŲżżż╩żżŠņ╣ńż╚╚µż┘żŲÅ]┼┘ż¼µ£ż»░Ńż”ĪŻCPUż½żķGPUżž╠┐╬ßż“ĮążĘżŲGPUż╬źßźŌźĻż╚GPUż╚ż╬żõżĻŲDżĻż“Ęąż┐ĖÕCPUż╦żĮż╬źßźŌźĻźŪĪ╝ź┐ż“┴„żĻĪ󿥿ķż╦CPUż╬źßźŌźĻżž┴„żļż╚żżż”Š}┤ųż“Š╩ż»ż│ż╚ż¼żŪżŁżļż½żķż└ĪŻźßźŌźĻż“CPUż╚GPUż╩ż╔ż╚Č”Ń~żĘżŲżżżņżąĪó▒ķōQ±T▓╠ż“┴Ū┴ßż»CPUż╦┴„żļż│ż╚ż¼żŪżŁżļĪŻż│ż╬ż┐żßż╦żŽźßźŌźĻż╬Ų▒▐k└ŁĪ╩ź│źęĪ╝źņź¾źĘĪ╦ż¼ĄßżßżķżņżļĪŻ╣Łżżźąź¾ź╔╔²ż╬HBMżŪĮj╬╠ż╬źßźŌźĻż“CPUż╚┴„£p┐«żŪżŁżņżąČ╦żßżŲ╣ŌÅ]ż╦ż╩żļĪŻ
ż│ż╬2.5D×æē俎┐▐2ż╬żĶż”ż╦ĪóSoCż╚HBMż“6Ė─Īóźżź¾ź┐Ī╝ź▌Ī╝źČż“─╠żĘżŲ└▄¶öżĘżŲż¬żĻĪó1źčź├ź▒Ī╝źĖż╦SoCż╚HBMźßźŌźĻż“┼ļ║▄żĘż┐Ę┴ż╦ż╩żļĪ╩╗▓╣═½@╬┴3Ī╦ĪŻżĄżķż╦źšźĪźżź¾źįź├ź┴źĄźųź╣ź╚źņĪ╝ź╚ż“ĘążŲHDIĪ╩High Density InterconnectionĪ╦┤łż╦═Ņż╚żĘĪó║ŪĮ¬┼¬ż╩ICźčź├ź▒Ī╝źĖż╚ż╩żļĪŻż│ż│żŪżŽźŽź¾ź└źąź¾źūż╬ĮjżŁżĄż“Š»żĘż║ż─│╚ĮjżĘż╩ż¼żķĪóźūźĻź¾ź╚övŽ®┤łż╦╝┬äóż╣żļICźčź├ź▒Ī╝źĖż╦╗┼æųż▓żŲżżżļĪŻ└▄¶öż╦żŽµ£żŲźŽź¾ź└ź▄Ī╝źļż“╗╚ż├żŲżżżļĪŻ
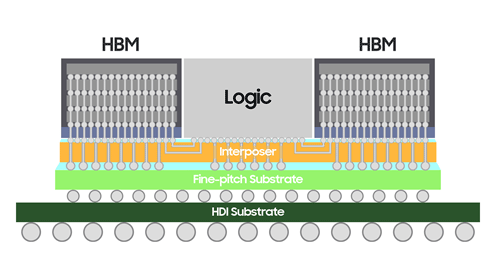
┐▐2ĪĪźżź¾ź┐Ī╝ź▌Ī╝źČż“─╠żĘżŲSoCż╚źßźŌźĻż“└▄¶öĪĪĮąųZĪ¦Samsung
║ŻĖÕĪóźŪĪ╝ź┐ź╗ź¾ź┐Ī╝żõAIĪóź╣Ī╝źčĪ╝ź│ź¾źįźÕĪ╝ź┐ż╩ż╔ż╬HPCĪó5Gź│źó┤├ŽČ╔ż╬ź═ź├ź╚ź’Ī╝ź»źūźĒź╗ź├źĄż╩ż╔źŽźżź©ź¾ź╔ż╩×æēäż¼═▀żĘżżźµĪ╝źČĪ╝ż╦Ė■ż▒Īóźčź├ź▒Ī╝źĖź¾ź░źĄĪ╝źėź╣ż“─¾ČĪżŪżŁżļżĶż”ż╦ż╩żļĪŻ╝┬║▌ż╦żŽAmkorż¼─¾ČĪż╣żļż╬ż½Samsungż╩ż╬ż½żŽ£½żķż½ż╦żĘżŲżżż╩żżĪŻ
╗▓╣═½@╬┴
1. ĪųAppleż╬┐ĘĘ┐SoCĪóGPUĪ”źėźŪź¬ĄĪē”ż“Į╝╝┬żĘż╩ż¼żķŠ├õJ┼┼╬üż“║’žōĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2021/10/20)
2. ĪųĪžŲ╚śOź┴ź├źūżŽ├”├║┴Ūż“╝┬╣įż╣żļæųżŪ╔į▓─’LĪ┘NokiaĪó┐ĘźūźĒź╗ź├źĄ│½╚»ż╬═²ĮyĪūĪóź╗ź▀ź│ź¾ź▌Ī╝ź┐źļ (2021/10/14)
3. "Samsung Announces Availability of Its Leading-Edge 2.5D Integration ĪŲH-CubeĪŪ Solution for High Performance Applications", Samsung Newsroom (2021/11/11)


